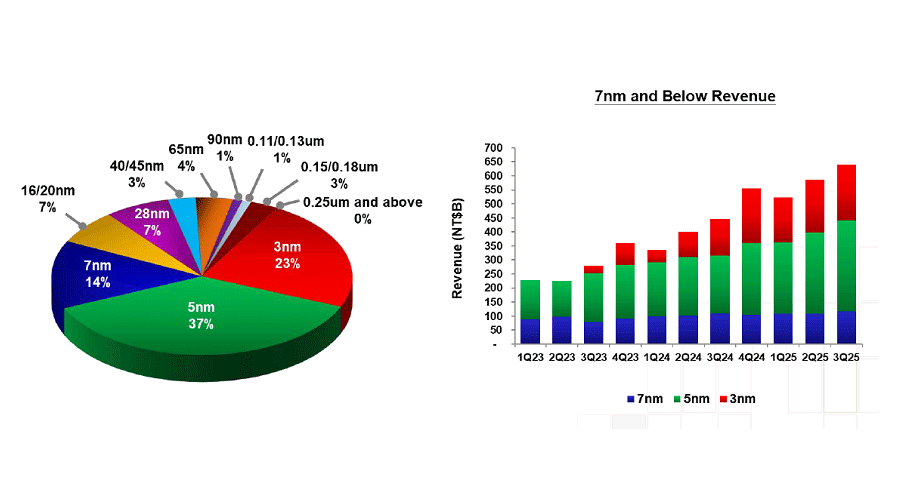
2025年10月20日
|週間ニュース分析
10月16日、TSMCが2025年第3四半期(7〜9月)の決算発表を行った。翌17日の日本経済新聞で一部報告されたが、質問も含めて日本と関係する部分を中心に、その詳細を報告しよう。この期における売上額は前年同期比40.8%増の331億ドル、営業利益率は50.6%と前年同期よりも3.1%ポイント増加した。ドル安・台湾元高の影響で台湾元では売上額は30.3%増の9899.9億台湾元になっている。
[→続きを読む]

2025年10月16日
|産業分析
ベルギーの半導体研究所imecが主導する次世代自動車用チップレット計画ACP(Automotive Chiplet Program)に、GlobalFoundries、Infineon Technologies、Silicon Box、STATS ChipPAC、日本のティアフォーが参加した、とimecが発表した。自動車産業向けの要求に沿った先端チップレットのアーキテクチャを開発、採用するための組織だ。日本のASRA(自動車用先端SoC技術研究組合)はどうするか。
[→続きを読む]

2025年10月14日
|週間ニュース分析
米Intelが2nmノードよりも高集積の18A(オングストロームに起因)プロセスノードのSoCを2種発表、そのうちのパソコン用のSoC「Panther Lake」は製造を開始した。サーバー用Xeon 6+プロセッサ「Clearwater Forest」は2026年前半に量産が立ち上がる予定だ。Semicon Westが今年初めてアリゾナ州で開催された。またOpenAIがAMDに最大10%出資する。
[→続きを読む]

2025年10月 6日
|週間ニュース分析
先週末、富士通とNvidiaの協業の記者会見が行われた。共同でAI半導体チップを開発するという見出しの記事があったが、AIチップは共同で開発しない。三つの分野で協業するという発表である。自律的に進化するAIエージェントのプラットフォームの開発、HPC(高性能コンピューティング)に向けたコンピュータ基盤の開発と拡販、そしてAIのインフラを用いた顧客へのサービス提供、である。それぞれを紹介する。
[→続きを読む]

2025年10月 2日
|産業分析
Infineon Technologiesがクルマ向けのマイコン(マイクロコントローラ)にRISC-Vを導入すると4月に言明してから(参考資料1)半年、日本でもRISC-Vに興味を示す企業が増えたようだ。これまで組み込み関係の展示会でのRISC-Vブースは閑散としていたが、このほど開催したInfineon RISC-V Seminarでは350名が登録、300名以上が参加した。「これほど多くの人たちが関心を寄せてくれた」とインフィニオンジャパンの神戸肇社長は感激した。
[→続きを読む]
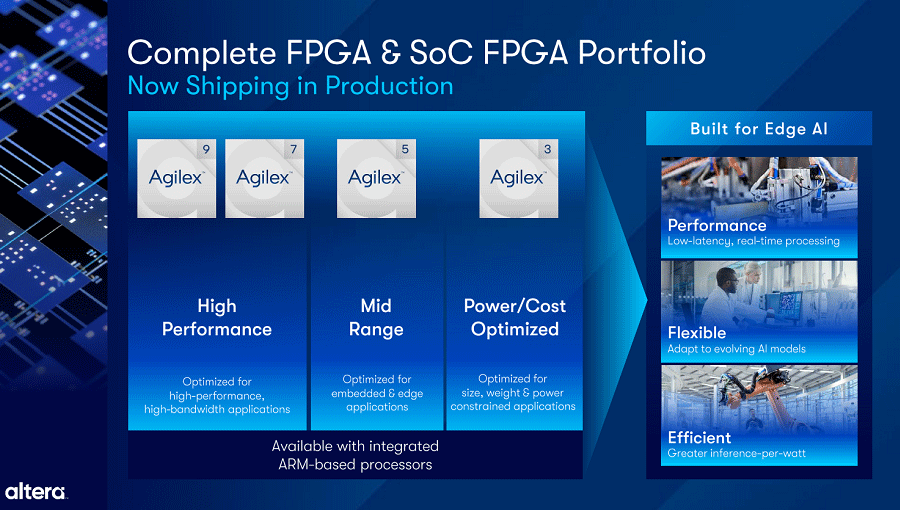
2025年10月 1日
|産業分析
FPGAメーカーのAlteraがIntelから2025年3月に独立したが(参考資料1)、実質的にIntelの子会社だった。このほどファンドのSilver LakeがAltera全株式の51%を購入、Intelの株式は49%になり、Intelは少数株主となりAlteraはほぼ完全独立になった。CEOのRaghib Hussain氏および日本法人社長のSam Rogan氏(図1)と共に新生Alteraを紹介した。
[→続きを読む]

2025年9月29日
|週間ニュース分析
NvidiaのGPUが高価すぎる、という声に応えて、これまでのGPU販売に加え、スタートアップ向けにリースも行うという噂がシリコンバレーに出ている。米国メディアは複数が報じている。また、中国のAlibabaと華為科技のAIチップの実力が明らかになってきた。日本のイビデンもAIチップの基板の生産量を2.5倍に引き上げるとしている。
[→続きを読む]

2025年9月26日
|産業分析
Infineon TechnologiesとロームがSiCパワー半導体のパッケージを共通にするための合意に達し、MoU(Memorandum of Understanding)を結んだ。Infineonはさまざまな形の表面実装パッケージを持っており(参考資料1)、ロームはハーフブリッジ構成のSiCモジュールDOT-247(挿入型)を持つ。互いにパッケージのポートフォリオが拡大すると共にセカンドソースを顧客に訴求できる。
[→続きを読む]

2025年9月24日
|技術分析(製造・検査装置)
測定器メーカーのKeysight Technologiesが毎年恒例のKeysight Worldを開催、今年は任意波形発生器やハイエンドオシロスコープなどを駆使する量子コンピュータの測定システムQCSも示した(図1)。1000Qbitsまで対応できるシステムだと誇示した。キモはどうやらノイズの影響をいかに下げるか、のようだ。量子状態の実現は熱振動を避ける所から始まる。
[→続きを読む]

2025年9月22日
|週間ニュース分析
先週末、NvidiaとIntelが今後のデータセンターとパソコン向け製品を数世代にわたって共同開発することで合意した。Nvidiaは50億ドルをIntelに出資する。この提携は、Nvidia側から見ると、x86アーキテクチャとNvidia GPUをNVLinkで結合することで、これまでにない最高のコンピュータを実現しようというものだ。データセンターのCPUに強いIntel側から見ても新しいコンピュータは魅力的に映る。
[→続きを読む]