Wolfspeed再起動、チャプター11からの素早い復帰で攻めに転ずる

SiCパワーデバイスの基板やデバイスを提供していたWolfspeedが再起動する。2025年6月に日本の民事再生法に相当する米連邦破産法第11条(通称チャプター11)の適用を申請、以来再建の道を歩んできたが、このほど財務の再構築を成功裏に終えた。フリーキャッシュフローの自己資金を元にSiCの200mm垂直統合ラインを活用していくという。 [→続きを読む]
» セミコンポータルによる分析 » 産業分析

SiCパワーデバイスの基板やデバイスを提供していたWolfspeedが再起動する。2025年6月に日本の民事再生法に相当する米連邦破産法第11条(通称チャプター11)の適用を申請、以来再建の道を歩んできたが、このほど財務の再構築を成功裏に終えた。フリーキャッシュフローの自己資金を元にSiCの200mm垂直統合ラインを活用していくという。 [→続きを読む]

Infineon Technologiesがクルマ向けのマイコン(マイクロコントローラ)にRISC-Vを導入すると4月に言明してから(参考資料1)半年、日本でもRISC-Vに興味を示す企業が増えたようだ。これまで組み込み関係の展示会でのRISC-Vブースは閑散としていたが、このほど開催したInfineon RISC-V Seminarでは350名が登録、300名以上が参加した。「これほど多くの人たちが関心を寄せてくれた」とインフィニオンジャパンの神戸肇社長は感激した。 [→続きを読む]
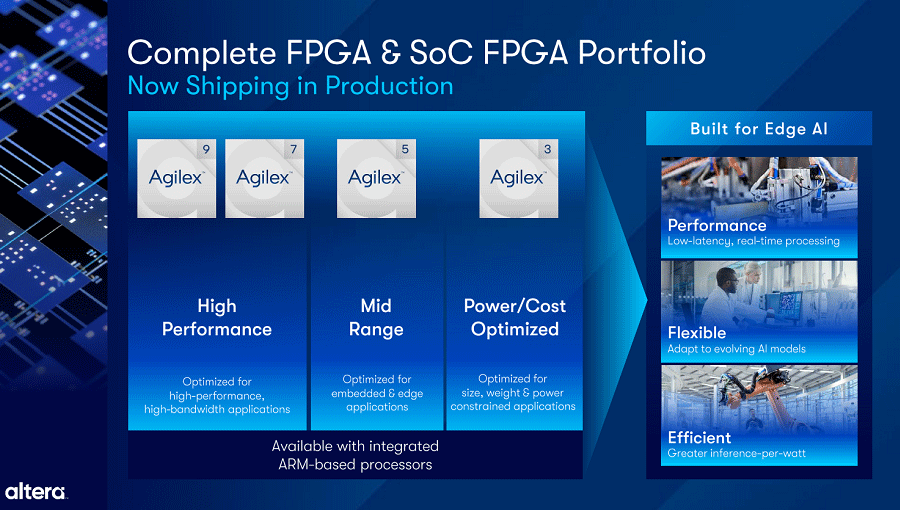
FPGAメーカーのAlteraがIntelから2025年3月に独立したが(参考資料1)、実質的にIntelの子会社だった。このほどファンドのSilver LakeがAltera全株式の51%を購入、Intelの株式は49%になり、Intelは少数株主となりAlteraはほぼ完全独立になった。CEOのRaghib Hussain氏および日本法人社長のSam Rogan氏(図1)と共に新生Alteraを紹介した。 [→続きを読む]

Infineon TechnologiesとロームがSiCパワー半導体のパッケージを共通にするための合意に達し、MoU(Memorandum of Understanding)を結んだ。Infineonはさまざまな形の表面実装パッケージを持っており(参考資料1)、ロームはハーフブリッジ構成のSiCモジュールDOT-247(挿入型)を持つ。互いにパッケージのポートフォリオが拡大すると共にセカンドソースを顧客に訴求できる。 [→続きを読む]

MEMSでトップシェアのBosch Sensortecは、年間10億個以上のインテリジェントMEMSセンサを出荷できるようになり、あと5年の2030年までに累計100億個にする目標を掲げた。Bosch内の小さなグループとして出発したBosch Sensortecは、創業20年で今やMEMS出荷額でトップになった(図1)。今後もエッジAIのセンサをスマートフォンやウェアラブル、ヒアラブル、スマートホームに注力していく。 [→続きを読む]

「半導体をけん引するこれまでの4つの波からAIという5番目の波を迎えるようになった」と9月5日、東京品川で開催されたSiemens EDA Tech Forum 2025 Japanにおいて、Siemens EDAのAIおよびSolido Custom IC担当のシニアVP兼ジェネラルマネージャーのAmit Gupta氏(図1)は述べた。これからは業務のワークフローにAIをいかに活用するかでTime-to Marketが決まるようになる。Gupta氏はEDAにAIを活用することで工数が半減すると述べている。 [→続きを読む]
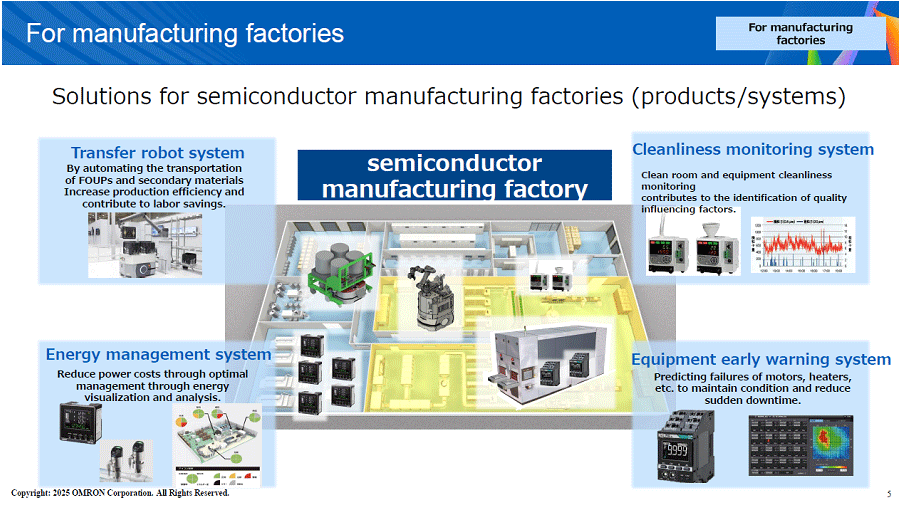
工業用のセンシングや制御機器に強いオムロンが半導体分野に力を入れる。会社として本格的に参入するため、半導体に特化した組織としてセミコンダクタ&インキュベーションセンタを2025年4月に設立した。同社は2021年、所有していた半導体工場をミネベアミツミに売却している。今なぜ半導体分野に再び進出するのだろうか。 [→続きを読む]

米中のサプライチェーン分断に対して半導体企業の経営層はどう対処しているだろうか。「AI、投資、サプライチェーン、政策:世界半導体企業経営層の本音」と題するレポートを、半導体団体のGSA(Global Semiconductor Alliance)と調査会社のIntegrated Insightsが発行した。世界の半導体および関連企業の経営層やマネージャーに聞いたアンケートをまとめた報告書である。日本ではセミコンポータルが企業へのアンケートを実施させてもらった。その概要を紹介する。なお詳細は9月のウェビナーで解説する。 [→続きを読む]

ファンドであるソフトバンクグループがIntelに20億ドルを出資することで合意に達した。Intelの普通株式をソフトバンク側が購入する形で出資する。米国内での先端技術と半導体イノベーションに投資する。Intelの製造部門では営業損益が赤字続きなので、Intel全体で営業赤字か黒字か、ぎりぎりの状態が続いている。製品部門そのものは営業黒字が多い。 [→続きを読む]

Siemens Digital Industries Software社は、半導体工場向けのPLM(Product Lifecycle Management)ソフトウエア「Teamcenter SLCM」がラピダスに採用されたことを明らかにした。Teamcenterは、システムを組むための部品管理フローのソフトウエアで、開発から量産、生産中止まで使用する部品やソフトウエア部品を一貫管理するシステムソフト。 [→続きを読む]