セミコン台湾で3DIC先端製造アライアンスが誕生
先週、セミコン台湾2025が開催され、AIがけん引する先端パッケージが注目されたようだ。9月11日の日本経済新聞は先端パッケージの講演が連日のように開かれたと報じた。特に3DICAMA(3DIC Advanced Manufacturing Alliance:先端製造アライアンス)を、TSMCとASEがリードして立ち上げた。日本でも広島大学がAIの普及で半導体需要が増えることから半導体システムを教えるプログラムを新設した。 [→続きを読む]
先週、セミコン台湾2025が開催され、AIがけん引する先端パッケージが注目されたようだ。9月11日の日本経済新聞は先端パッケージの講演が連日のように開かれたと報じた。特に3DICAMA(3DIC Advanced Manufacturing Alliance:先端製造アライアンス)を、TSMCとASEがリードして立ち上げた。日本でも広島大学がAIの普及で半導体需要が増えることから半導体システムを教えるプログラムを新設した。 [→続きを読む]

Nvidiaの次に時価総額の高い半導体企業としてBroadcomが注目されている。全企業の時価総額ランキングで8位であり、9位のTSMCよりも上位に来ている。そのBroadcomがChat GPTのような生成AIを生み出したOpenAIの半導体設計を請け負うらしいというニュースで先週は持ちきりだった。日本のレゾナックが先端パッケージのインターポーザ開発を狙った新プロジェクトでは27社が参加する。 [→続きを読む]
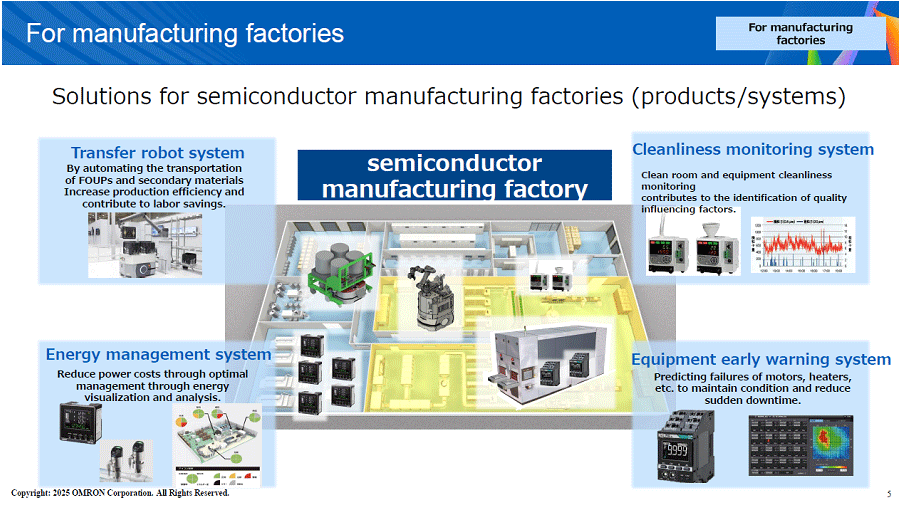
工業用のセンシングや制御機器に強いオムロンが半導体分野に力を入れる。会社として本格的に参入するため、半導体に特化した組織としてセミコンダクタ&インキュベーションセンタを2025年4月に設立した。同社は2021年、所有していた半導体工場をミネベアミツミに売却している。今なぜ半導体分野に再び進出するのだろうか。 [→続きを読む]

先週の目玉は、やはりNvidiaの2026年度第2四半期(2025年5〜7月期)における決算報告だろう。前四半期での発表時に同社が予想していた450億ドルを超えて467.43億ドル(6.87兆円)となった。前年同期比(YoY)では56%増、前四半期比(QoQ)でも6%増であった。本業の稼ぎを示す営業利益率は60.8%と驚異的な数字だ。 [→続きを読む]

先端半導体パッケージ市場予測が発表され、今後8年間の平均年成長率(CAGR)が6.8%になりそうだ。先端パッケージング技術は、TSMCのCoWoS(Chip on Wafer on Substrate)やFOWLP(Fan-Out Wafer Level Package)、チップレットなど従来の組立後工程とは違い、これまで以上の高集積を実現する中工程の技術である。 [→続きを読む]

米国政府がIntelに89億ドルを出資する、とIntelは 22日(日本時間23日)発表した。米国の技術・製造のリーダーシップを加速するためだとしている。また、理化学研究所は、スーパーコンンピュータ「富岳」の次世代機にNvidiaのGPUを使うことでNvidiaと提携した。スパコン性能のトップ10ランキングで、GPUを使っていない機種は富岳だけだった。 [→続きを読む]

ファンドであるソフトバンクグループがIntelに20億ドルを出資することで合意に達した。Intelの普通株式をソフトバンク側が購入する形で出資する。米国内での先端技術と半導体イノベーションに投資する。Intelの製造部門では営業損益が赤字続きなので、Intel全体で営業赤字か黒字か、ぎりぎりの状態が続いている。製品部門そのものは営業黒字が多い。 [→続きを読む]

セミコンポータルは、2025年上半期の世界半導体企業トップテンランキングを発表した。1位はNvidiaで890億ドル、2位がTSMCの556億ドル、3位Samsung、4位SK hynix、5位Intelとなった。以下、6位Qualcomm、7位Micron Technology、8位Broadcom、9位AMD、10位MediaTekとなった。1位Nvidiaの5〜7期は未発表だが予測値である。 [→続きを読む]

東京エレクトロンは、台湾子会社の元従業員1名がTSMCから機密情報を不正に取得した事案に関与していたことを確認したと発表した。先週は、ソニーとキオクシアから2025年4〜6月期の決算発表があった。すでに発表のあったルネサスを含め大手日本企業3社の間ではソニーが最も良い業績であった。また、OpenAIがGPT-5を発表したが、不正確な回答を減らし、正解率を高めた。 [→続きを読む]

世界の半導体市場は2025年第2四半期(2Q)も好調に推移している、とWSTS(世界半導体市場統計)が発表した。世界の半導体各社から2025年4~6月期の決算報告がほぼ出そろい、WSTSの見積もりにも確度が増すことになる。第2四半期(2Q)販売額は前年同期比(YoY)20%増の1800億ドルとなった。これで25年前半は、YoY18.9%の3460億ドルとなった。 [→続きを読む]