
2025年3月 5日
|産業分析
LED照明など積極的に照明分野に注力してきたOSRAMと、センサやその周辺ICを得意としてきたams(旧Austria Micro Systems)は2020年7月に合併したが、その後の活動について日本ではほとんど知られなかった。ams OSRAMの CEO兼取締役会会長であるAldo Kamper氏(図1)がこのほど来日し、今後の戦略について語った。狙う分野は、自動車、産業、医療、モバイル、である。
[→続きを読む]
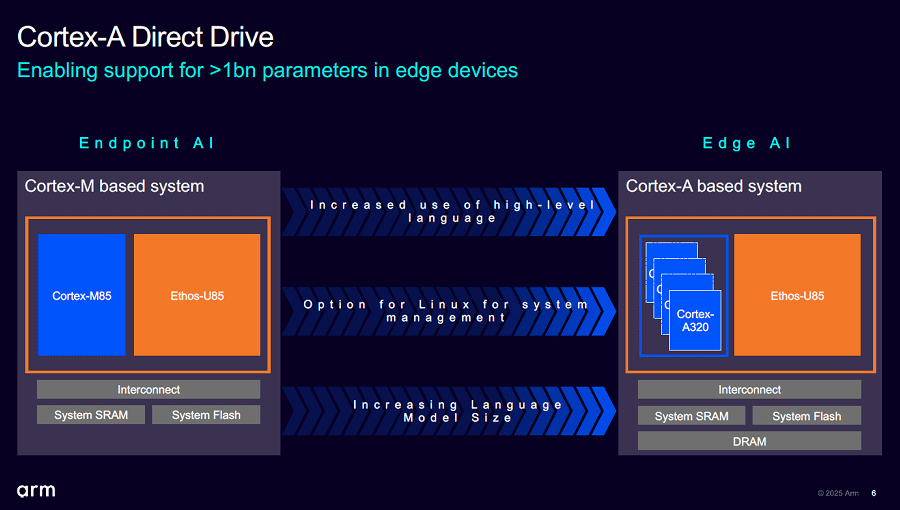
2025年3月 4日
|技術分析(半導体製品)
高性能なCPUとAI専用のNPU(ニューラルプロセッシングユニット)を集積したIP(知的財産)コアをArmが開発した。高性能ビデオ伝送をはじめとする高速IoT(Internet of Things)に対応するIPコアである。高性能な技術であるArmv9をエッジAIのプラットフォームとして使う用途が早くも生まれたために、このような高性能IoT向けのIPを開発した。具体的にはどのような用途だろうか。
[→続きを読む]

2025年3月 3日
|週間ニュース分析
先週はニュースが立て込んだ。Nvidiaの決算報告(参考資料1)をはじめ、Appleがテキサス州に新工場を設立するというニュースや、Amazonが生成AIを導入した音声アシスタント「アレクサ・プラス」などがあった。さらにWestern DigitalがNANDフラッシュ部門であるSanDiskをスピンオフさせ、ナスダック証券取引所に上場させた。
[→続きを読む]

2025年2月28日
|技術分析(プロセス)
Micron Technologyが1γnmノードのDDR5DRAMをサンプル出荷した。1γnmというサイズは10nmクラスのようで、EUV装置の導入が必須になる。Micronの微細な技術によって、スピードは現世代の1βnmノードのDRAMと比べ、8Gbpsから9.2Gbpsと高速になり、消費電力は20%削減され、集積度は30%上げることができる(図1)。
[→続きを読む]

2025年2月28日
|産業分析
Nvidiaの第4四半期(4Q)における決算が明らかになった。売上額は前年同月比(YoY)78%増、前四半期比(QoQ)で12%増の393億ドル、営業利益はNon-GAAPで255億ドル、GAAP(米国会計基準)でも240億ドルとなった。利益率にしてNon-GAAPの255億ドルは64.9%にも達している。同社は7カ月連続、過去最高を記録してきたと言える。さらに次の四半期も4Q25の数字を超えると予想している。
[→続きを読む]
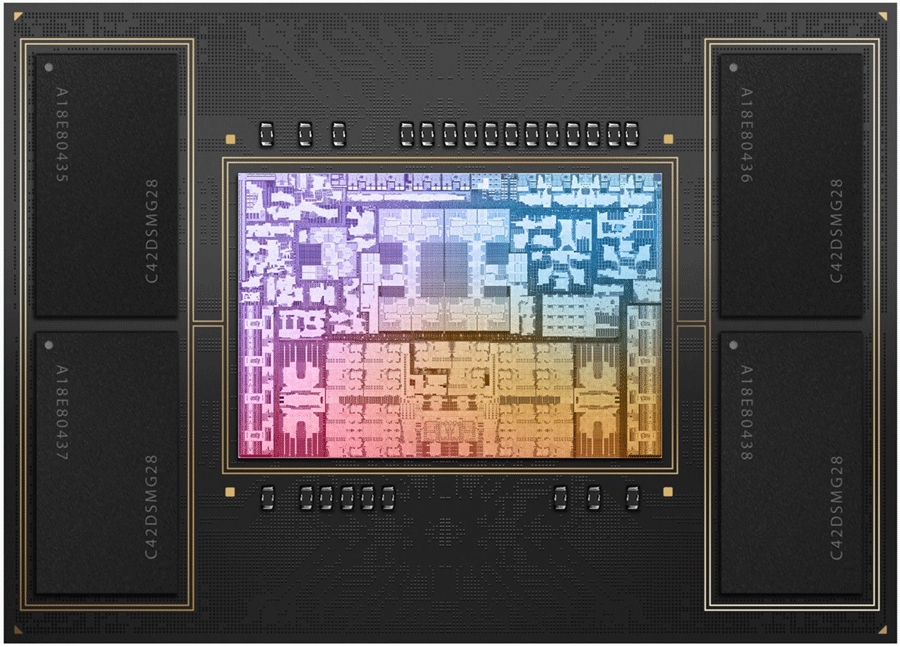
2025年2月25日
|週間ニュース分析
米中貿易摩擦によって、自国内でモノづくりをせざるを得なくなってきた中国は、その生産力を付けてきた。一方で、Appleがサーバー工場をテキサス州に作ることを発表、日本は自国内に発電所に沿った形でAIデータセンターを作るという構想を発表した。中国の力はどの程度なのか、おぼろげながらその像が少しずつ見えてきた。
[→続きを読む]

2025年2月20日
|産業分析
OSAT (Outsourced Semiconductor Assembly and Test:後工程専門の請負ビジネス) で世界トップの台湾ASE(Advanced Semiconductor Engineering:日月光投控)がマレーシアのペナン島にある工場敷地内で第5工場を立ち上げると発表した。現在の3.4倍となる340万平方フィートの工場になる。なぜいま拡張するのか。
[→続きを読む]

2025年2月18日
|市場分析
2024年におけるシリコン半導体ウェーハの出荷面積が前年比2.7%減の122億6600万平方インチだったとSEMIが発表した。その年のウェーハ売上額は同6.5%減の115億ドルだった。出荷面積の減少よりも出荷売上額の減少の方が大きいということは、在庫調整がゆっくりで、ファブの稼働率を上げるような大量生産品目のデバイス需要が弱かったことを意味する。
[→続きを読む]

2025年2月17日
|週間ニュース分析
先週、キオクシアとソニー、中国SMICから2024年第4四半期(10〜12月期;4Q)の決算発表があった。キオクシアが回復、ソニー半導体は昨年並み、SMICは30%成長超えという結果だった。台湾の月次が発表され、TSMCは相変わらず急成長だ。小さな記事でTSMCの取締役会が米国で開催されるというニュースがあった。
[→続きを読む]
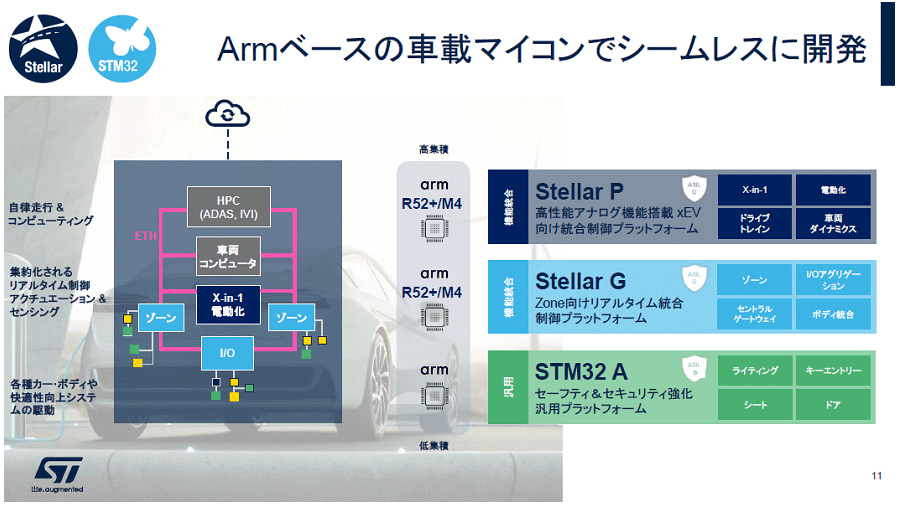
2025年2月14日
|技術分析(半導体製品)
STMicroelectronicsは、ゾーンアーキテクチャに向いたMCU(マイコン)「Stellar」のシリーズを明らかにした。先行して販売していたStellar Eシリーズに対して、Armマルチコアによる仮想化技術を採り入れている。その高集積化のためNORフラッシュメモリに代わりPCM(相変化メモリ)を用い28nm、18nmへと微細化で対応する。
[→続きを読む]