OSAT2位のAmkorが1位のASEに続き日本に研究開発拠点を設置
OSAT(半導体後工程の製造請負業者)世界2位の米Amkor Technologyが福岡市に研究開発拠点を設けると発表した。AI向けチップの実装に先端パッケージが使われており、先端パッケージを巡る動きは激しい。米Applied Materialsはシンガポールで先端パッケージの研究開発を強化する。先端パッケージングからパワー半導体もカバーできるモールド装置をアピックヤマダが開発した。
今回のAmkorの進出は、今年の7月31日にOSAT最大手の台湾ASEと福岡県北九州市が市有地約16ヘクタールを34億円で取得する仮契約を締結したことに続く、日本でのOSATの活性化になる。Amkorは、日本初の研究開発拠点を2025年4月に福岡市に設けるとした。拠点は市内のビルに置き、その広さは1063平米で、その半分をクリーンルームとする。Amkorの新拠点では、電力制御につかうパワーモジュール(複合部品)やイメージセンサーといった、自動車向け半導体の後工程の先端技術や量産技術、材料に関する基礎開発などを手掛ける、と11月29日の日本経済新聞が報じた。
ASEはすでに2004年にNEC山形工場を買収し手に入れ、生産を続けている。7月末のASEジャパンが契約の主体であり、ASEは日本で生産を広げていくことが窺える。Amkorは大分県の仲谷マイクロデバイスが東芝、Amkorの資本を入れてJデバイスとなり、12年には富士通セミコンダクター、13年にルネサスエレクトロニクスからも後工程拠点を買収し、15年にAmkorの拠点となった。共に後工程の生産拠点を日本に持っているが、先端パッケージ研究開発拠点は持っていなかったため、その材料開発に強い日本企業とのコラボを求めて今回の開発拠点となった。
先端パッケージはAI以外にも、高性能コンピューティング技術に欠かせないため、SoCチップ+周辺メモリ構成はNvidiaのAIチップだけではなく、AppleのM1~4プロセッサの実装にも同様なパッケージングを用いている。ただし、M1〜4プロセッサはHBMではなくDDR DRAMではあるが、チップ+周辺メモリ構成は広がりつつある。
先端パッケージは、後工程とは違い、TSV技術や2.5D/3D-IC技術をふんだんに使い、超高集積なICを製造する。モノリシックでの集積度よりも高い集積度のICを低コストで実現する技術として注目されている(詳細は、SPIフォーラム「チップレット、先端パッケージ技術とその未来(II)」を参照)。
前工程の製造装置装置大手、Applied Materialsは、「シンガポール科学技術研究庁、シンガポール国立大学、南洋理工大学などと研究開発で協業することで覚書を交わした。レゾナック・ホールディングス、Intel、TSMCなどの幹部とシンガポールで会合し、協業の方法を討議した」、と27日の日経が報じた。シンガポールでは先端パッケージのスタートアップ、Silicon Box社が操業し始めており、前工程だけではなく先端パッケージのインフラが整えつつある。
半導体チップをプラスチック樹脂で封止する、モールディング装置のアピックヤマダは、先端ロジックからメモリ、そしてSiCパワー半導体の樹脂封止にも使える新型モールド装置「MS-R」を発売した。この装置は、従来のトランスファモールドだけではなく先端パッケージ用のコンプレッションモールドや、ハイブリッドボンディング、パワー半導体のシンタリング接合にも使えるフレキシブルなマシンとなっている(図1)。
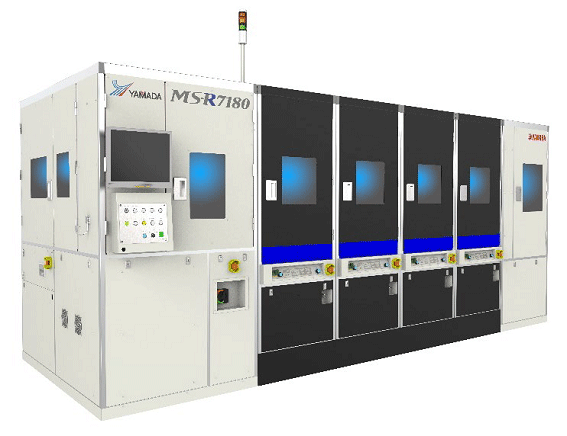
図1 アピックヤマダのトランスファー成型とコンプレッション成型が可能なモールド装置 出典:アピックヤマダ
トランスファー成型とコンプレッション成型のプロセスの変更などを1台の装置(プラットフォーム)で対応する。樹脂流動シミュレーション解析によって金型を設計しており、高剛性金型ベースユニットと高精度高圧クランプ金型ユニットを新開発した。先端パッケージでのチップレットの積層にも狭小なギャップにボイドレスで均一に樹脂を充填させることができるという。


