ASMLがEUV露光の生産性を5割向上させる1000W光源技術を開発
去る2月24〜26日に米国カリフォルニア州サンノゼで開催された2026 SPIE Advanced Lithography + Patterning学会で、蘭ASMLの米国法人(元は露光装置光源メーカーのCymer, 2013年にASMLが買収)が、極端紫外線(EUV)の光源出力を従来の500W(販売中の最新モデルに搭載されている光源の出力)〜600W(開発中のモデル)からいっきに1000Wに上昇させる技術開発に成功したと発表した(図1、参考資料1参照)。

図1 2026 SPIE Advanced Lithography + Patterning 学会でのASML米国法人の発表要旨 出典:同学会ウェブサイト、参考資料1
毎時330枚の300mmウェーハ露光が可能に
ASMLでEUVリソグラフィを統括する執行副社長テウン・ファン・ゴッホ氏は、「顧客は現在1時間当たり最大約220枚の300mmシリコンウェーハを処理しているが、光源出力を1000Wに上げることにより、2020年末までに1台のマシンで1時間当たり約330枚のウェーハを処理できるようになるだろう」と述べている。
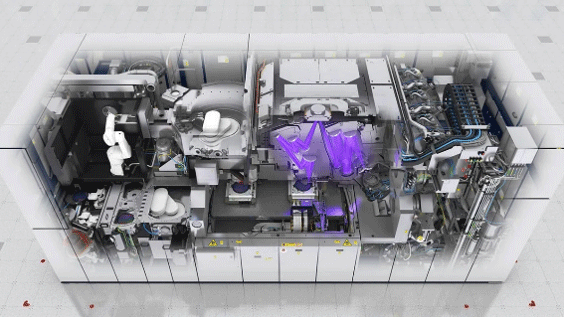
図2 中央に光学系を配置したEUV 露光装置の内部 出典:ASML
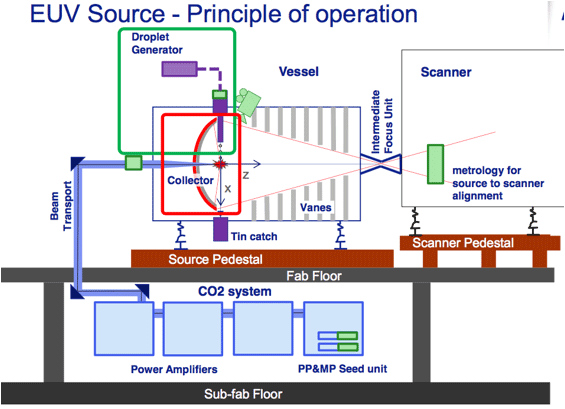
図3 EUV露光装置の光源部分の概略図 あくまでもEUV発光原理を模式的に示した図であり、実機の構造ははるかに複雑である 出典:ASML
13.5nmの波長のEUV光を生成するために、溶融スズの液滴の流れをチャンバ内に噴射し、そこで強力な二酸化炭素レーザーによってそれらをプラズマ化するわけだが、ASMLはスズの液滴の数を1秒あたり約10万個に倍増し、既存の単一の成形バーストではなく、2つのより小さなレーザーバーストを使用してそれらをプラズマに変換することで出力を1000Wに上昇させることに成功したという(図2、図3参照)。
ASMLのEUV 露光装置量産モデルの光源出力向上を振り返ると、2013年に量産向けEUV露光装置という位置づけの「NXE:3300B」の光源は当初10Wレベルであったが、2015年にフィールドで80Wによる稼働を実現。以降も重ね合わせ精度の向上なども含めた高性能化が進められてきており、2021年に出荷された「NXE:3600D」では350Wへと光源出力が増強された。さらに、2024年に出荷が開始され、ラピダスも導入したことでも知られる「NXE:3800E」では出力が500Wへと引き上げられ、2026年後半から2027年前半に出荷開始予定の次世代機「NXE:3800F」で600W光源が搭載される予定となっている。2030年までには1000Wに引き上げられるメドが立ったという。
「EUV実用化は不可能」を可能に
かつて、ニコンのトップは、「EUV露光は、超音速旅客機コンコルドのように技術的には素晴らしくても実用化は不可能」との見立てでEUV関連の開発を止めてしまった。しかし、ASMLは、 「不可能」を可能にすべく莫大な開発費と人材リソースを投入して実用化に成功し、さらに高解像度・高スループット機種の開発に取り組んでいる。AI需要の持続的な成長に伴い、高性能EUV露光装置の需給が逼迫しており、同社は多数の受注残を抱えている。
かつては最強のライバルだった日本勢を蹴落して世界EUV露光装置市場を独占して快進撃を続けるASMLの世界半導体製造装置業界売上高ランキングトップの座はますます強固なものになりそうである。
参考資料
1. SPIE Advanced Lithography+Patterning プログラム
2. 台湾・經濟日報、2026年2月25日付記事


