ASML、次世代液浸リソHolistic Lithography の全貌を明らかに
世界トップのリソグラフィメーカーであるオランダのASMLがいよいよ狭まってくるプロセスウィンドウを最適化し、歩留まりを確保できる統合的なリソグラフィ技術(Holistic Lithographyと呼ぶ)についてSEMICON Westで発表していたが、このほど日本の9メディアにも公開した。これは45nm、38nm、32nm、22nmと微細化が進むにつれ狭くなるプロセスウィンドウに対処し歩留まりを確保するための総合リソグラフィ技術である。

この統合的リソグラフィ技術は、実際のリソグラフィ装置(スキャナー)のプロセスウィンドウを改善する。基本的に3つの考えに基づいてプロセスウィンドウを最適化する。一つがスキャナーのチューニングで最適なスキャナー条件 (LithoTuner、FlexRay) を設定する。二つ目はパターン検証 (Tachyon LMC) で、本番前のテスト露光の回数を減らす。三つ目はパターンの最適化(Tachyon OPC+、Tachyon SMO)で、プロセスウィンドウを広げる。
これら3つの考えを統合したリソ装置を実現するわけだが、ASMLが買収したブライオン社の光源シミュレータであるTachyon SMO(光源のマスク最適化)を用いて、光の条件と光源形状を計算する。これによると、例えばDRAMのコンタクトをスキャナーXT:1900iでパターニングする例では、対称的な4カ所の光源(4重極)の場合、シミュレーションしなければ焦点深度が72nmしか得られないが、Tachyon SMOで最適化すると104nmまで深まった。光源形状を対称的な6カ所(6重極)にしてTachyon SMOで最適化すると120nmになり、さらに光源の形状を自由に変えられるような場合だと130nmまで深くなることがわかった。
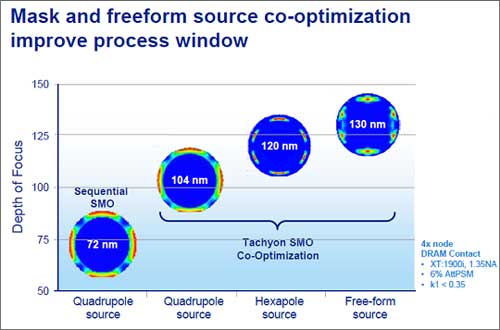
そこで、光源形状を自由に変えられるようなFlexRayとASMLが呼ぶ自由照明技術を開発した。この技術を使えば、これまでは照明光源とDOE(回折光学素子)を使って4重極光源などを作ってきたが、これをプログラム可能なMEMSマイクロアレイに置き換えた。FlexRayは、ちょうど米テキサスインスツルメンツ社のDLPプロジェクタに使われたマイクロミラーと似たようなマトリクス状にMEMSミラーを多数並べたようなもので、個々のミラーはXとY方向に動くため、光を自由にどの方向にも反射させることができ、どのようなSMOの形にでも変えられる。
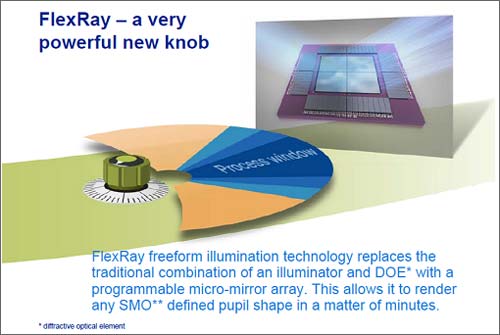
パターンそのものの形状についてもやはりブライオンのリソシミュレータLithoTunerを用いて、歩留まりを落としそうなパターンを検出し、修正する。スキャナーを調整してパターンを修正できるものは次の4つ;ホットスポットとレンズの温度上昇、スキャナー間のバラつき、CD(critical dimension)のバラつき、である。例えば、LithoTuner DSO (Design Specific Optimization)を使うと、欠陥になりそうなパターンの個所(ホットスポット)を同定し、取り除くことができる。例えば、パターン同士がくっついてしまいそうな場所を特定し、あらかじめパターン間を広げておくといった対応をする。結果的にTATが短くなる。

リソシミュレータである程度修正したとしても、実際に製造する前に最後に検証するためTachyon LMCを使って作り直しを避け、製造を遅らせないようにする。作り直しがあると、マスク1枚当たり14日の遅れが発生するとしている。Tachyon LMCは、焼き付けるときの欠陥を予測するというシミュレータであり、レチクルを製造する前の歩留まりの問題を把握する。
Tachyonのプラットフォームがシミュレーションに必要な計算は、インテルやAMDのプロセッサに依存する。10個のクワッドコアCPUを使っているが、10μm角の計算に2〜3時間かかるとしている。チップ全体のフルベリフィケーションはチップによって2〜3時間から2〜3日かかるという。クリティカルなパターンがどれだけあるかによって計算時間は違うとしている。

最後に、スキャナーの安定性を上げるBaseLinerは、TWINSCANのオーバーレイと焦点の安定性を維持する。これまでは装置を毎日使っていて、キャリブレーションを頻繁にしてきた。しかし、その間装置の稼働は止まりアベイラビリティが下がった。すなわち1日の生産性が落ちた。
今回のBaseLinerは、必要以上にキャリブレーションしない。キャリブレーションに時間がかかるためだ。より厳しいコントロールをすることで、1日当たりに生産できるウェーハ数を増やすことができる。測定はモニターウェーハを使って装置の外で行い、その結果を装置にフィードバックして調整する。BaseLinerはチャックとチャックとの間の焦点のばらつきを管理しすぐに修正することで、焦点のばらつきを減らすことができる。
ASMLは統合的リソグラフィツールをEclipseというリソグラフィパッケージでも提供する。EclipseをR&Dに導入すると、最適なプロセスウィンドウでの設計ルールの確認ができ、量産効果を取り込める。開発期間を3〜6ヵ月短縮できる可能性があるとしている。


