セミコンジャパン2023、先端パッケージング技術が続出(2)
3D-ICでは積み重ねるチップをウェーハ段階から薄く削り取らなければならないが、従来は、約850µmの厚さのシリコンウェーハの大部分(90%程度)を削って捨ててしまっていた。環境にもコスト的にも悪かった。そこでウェーハ表面を薄くはぎ取って、残りを再利用するという発想が出てきた。2部ではこれらとテスターについて紹介する。(第1部はこちら)
プロセス装置の強い東京エレクトロン(TEL)も先端パッケージング向けの製造装置に取り組んでいる。今回発表したのはチップを3次元的に積み重ねていく場合にチップを薄く削らなくてはならないが、分厚いウェーハで形成したIC回路部分だけの厚さだけ、ウェーハをはぎ取ってしまうという技術(図5)で、TELはXLO(Extreme Laser Lift-off)技術と呼んでいる。
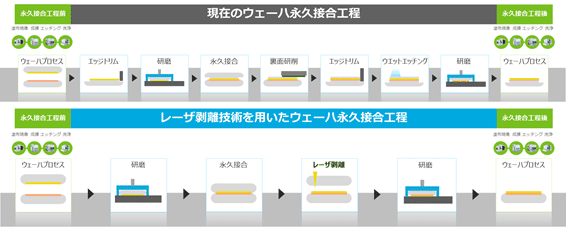
図5 東京エレクトロンのウェーハ剥離技術の一例 出典:東京エレクトロン
3次元ICでは、IC回路を形成したウェーハ上に、別のウェーハをフェイス2フェイス(face to face)で形成する場合、使わないバルクシリコンを研磨して薄くなるまで削っていた。その後のTSV(Through Silicon Via)などで深い溝に電極を形成する場合に厚ければ作業時間がかかりすぎてしまうからだ。分厚いシリコンを捨ててしまうため、無駄が生じるだけではなくその処理のために必要なエネルギーなど環境負荷が大きかった。
そこでTELが開発したのは、本来削り取るべきバルクシリコンの上からレーザーを当て、しかも、削り取りたい深い部分に焦点を合わせ、ウェーハ全面にスキャンすることで、ウェーハを剥がしとる。13日にセミコンジャパンで講演したTELの河合利樹代表取締役社長は、はぎ取ったウェーハを再利用することを検討しており、まだ実用化まで至らないが開発中だと述べている。
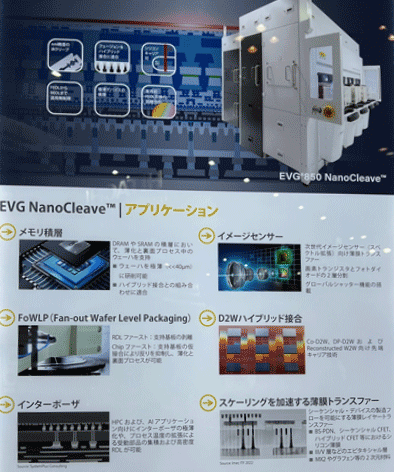
図6 EVGroupがポスター展示したウェーハ剥離装置EVG 850 NanoCleaveの応用例
レーザーによってウェーハを薄くはぎ取る技術は、SiCやGaNでも行われているが、TELが狙ったのは3D-ICへの応用だ。またTELと同様、EVGroupも同様の製造装置を製品化しており、セミコンジャパンでもNanoCleaveという名称でポスター展示していた(図6)。TEL同様、HBM(High Bandwidth Memory)のようなメモリ積層やFO-WLP(Fan Out Wafer Level Packaging)、インターポーザ、イメージセンサ、ダイ2ウェーハ(Die to Wafer)接合などの先端パッケージング技術への応用を狙っている。レーザーを照射したウェーハ内部の熱は一瞬高温になるだけなので、焦点からずれているIC回路にはほとんど影響を与えないという。
先端パッケージング技術は、良否判定や実力の測定を行うテスターにも影響を与えている。テスターのアドバンテストは、2.5D/3D-IC向けのテストハンドラーHA1200やHBM向けのチップスタック後のテスター、高集積ICに求められる高速・高帯域幅・多ピン化などに対応したSoCテスターV93000と共に使う高速シリアルインターフェイス用のカード「Pin Scale Multilevel Serial」(図7)を開発している。

図7 高速シリアルインターフェイスに対応したV93000用のカード(左)とV93000 EXA Scaleテスター本体 出典:アドバンテスト
生成AIやHPC、サーバーなどの頭脳となるSoCの入出力IF(インターフェイス)はますます高速になるため、それに対応するテスターV93000 EXA Scaleに差し込むカード(ボード)の機能・性能は、16レーンの並列をテストでき、最大32Gbpsのデータレートを持ち、さらに1か0だけのNRZ(Non Return to Zero)信号だけではなく、振幅の多値化を使うPAM(Pulse Amplitude Modulation)3やPAM4信号にも対応する。
3D-ICでは、例えばHBMのテストなどではロジックウェーハの上にダイを4枚あるいは8枚スタックしているが、ダイレベルで良品だとしてもスタック後に何らかの不良が発生しているかもしれない。そのためにテスターで良否を判定する必要がある。アドバンテストは、ウェーハ上でHBMをテストできるようなハンドラーHA1200を開発した。これまでOSATがパッケージ後にテストしていた項目を全てウェーハ上で確認できるようにしている。さらに、SoCでは定電圧化が進んではいるが大電流化も著しいため、許容発熱がこれまで1000Wや1500Wまでのハンドラーが多かったが、今回、アドバンテストはオプションだが2000Wまで対応できるような温度制御機能を持たせた。
さらに今回はNANDフラッシュテスターとして最大1024個のフラッシュメモリチップをウェーハ上で同時に測れるテスターT5230、さらにウェーハレベルのバーンインができる最大5.4Gbpsの高速インターフェイスを設けたウェーハソート機能を設けたT5835、最大32Gbpsの高速シリアルインターフェイスに対応できるパッケージに封止されたNANDフラッシュメモリ(コントローラ内蔵)やSSDなどをテストするT5851-STM32Gなどもリリースした。新しいPCIe Gen5などに対応できる。さらにHBMテスターも開発中のようだ。


