ルネサス北日本、QFNより高温動作可能な車載向け新型LSIパッケージを開発
ルネサス北日本セミコンダクタは、放熱板を付けた形のQFNに似た形のICパッケージを半導体パッケージ技術展で提案した。Pro.Quadと呼ぶこのパッケージは、リードフレームのメタルの板をパッケージ裏面の中央に配置しているだけではなく、パッケージ外形よりもリードをわずか外へはみ出させた形に設計することにより、リードとパッケージが基板にしっかりと密着した格好になる。このため熱を逃がしやすくなる。Pro.Quadと名付けたのはこの出っ張り(protrude)から来ているという。
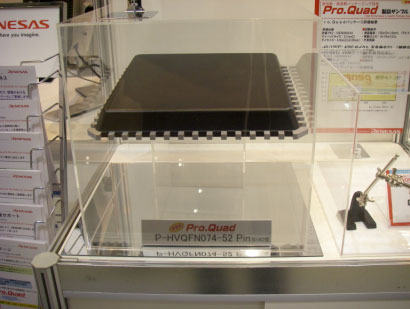
QFNだとリードメタルは裏面に隠れパッケージの上からは見えないが、このPro.Quadは各辺からリードがわずかはみ出している。Pro.Quadは実装するとメタル部分がプリント板に密着するため、熱抵抗を下げることができ、許容電力を上げたり、使用温度範囲を高くできるというメリットがある。わずかな出っ張りと角のメタルパッドからも放熱できる。ちなみに6mm角のQFNと、このPro.Quadを比べるとチップの熱は15~16℃下がるという。
今のところ、QFNパッケージは6mm角で36ピン、8mm角で52ピン、9mm角で60ピンを用意している。ピンピッチはいずれもJEDEC準拠の0.5mm、取り付け高さはいずれも1mm以下である。
ただ、放熱板をモールドに共存させる場合、メタルと熱可塑性樹脂との熱膨張係数の差が大きくなると、樹脂がはがれたり、樹脂とメタルとの間に隙間ができる恐れがある。このPro.Quadはこの問題を克服しており、-40〜+125℃での温度サイクル試験はすでに4000サイクルをクリヤーしている。車載アプリケーションの要求は1500サイクルであるから、ルネサスはその倍の3000サイクルを目標としてパッケージを開発した。-40〜+85℃の温度サイクル試験でも5500サイクルをクリヤーしている。
モールド樹脂は、シリコンとの熱膨張係数を合わせるためシリカのフィラーを目一杯充てんするが、今回のようにメタルとの熱膨張係数を合わせるため、さまざまな材料の樹脂とメタルでの組み合わせを行い、温度サイクル試験をクリヤーした。従来のパッケージでは温度サイクル試験を繰り返すと、4隅に応力が集中し、基板とはがれやすくなるが、この新しいパッケージだと基板との密着性が増すため、実装したときの機械的強度も高いという。
加えて、半田の付き具合を目視でチェックできるというメリットもある。従来のQFNパッケージは、ハンダ付けした後に半田ボールがきれいに付いているか目視では見ることができなかったが、このPro.Quadなら出っ張りの部分で半田のフィレットを目視で確認できる。


