LEAP§őń„ĺ√»ŮŇŇőŌ°¶…‘īÝ»Įņ≠•Š•‚•Í§Ō•ő•§•ļ•ř°ľ•ł•ůĻ≠§≤°ĘĻ‚Ĺłņ—≤ĹŐ‹Ľō§Ļ
∑–ļ—Ľļ∂»ĺ °¶NEDO° Ņ∑•®•Õ•Ž•ģ°ľé•Ľļ∂»ĶĽĹ—ŃŪĻÁ≥ę»ĮĶ°ĻĹ°ň§¨ĽŔĪÁ§Ļ§Ž°÷ń„√ļŃ«ľ“≤٧ھ¬łĹ§Ļ§Žń∂ń„ŇŇįĶ•«•–•§•Ļ•◊•Ū•ł•ß•Į•»°◊§őņģ≤Ő ůĻū≤٧¨Ļ‘§Ô§ž°Ęń„ŇŇįĶĶĽĹ—§őŅ Ňł§¨»Į…ŧĶ§ž§Ņ°£ł∂Ľ“•ž•Ŕ•Ž§ő»ýļŔ≤ŧň∂Š§Ň§Į§ň§ń§ž°Ę…‘Ĺ„ ™ł∂Ľ“§őĪ∆∂ѧ¨ł≤√ݧň…ŧž§Ž§Ť§¶§ň§ §√§∆§≠§∆§§§Ž°£∆įļÓŇŇįĶ§Ú≤ľ§≤°Ęł∂Ľ“•ž•Ŕ•Ž§ňń©ņÔ§Ļ§ŽĽÓ§Ŗ§¨§≥§ő•◊•Ū•ł•ß•Į•»§«§Ę§Ž°£IEDM2012§«§‚»Į…ŧĶ§ž§ŅĶĽĹ—§‚īř§Š§§§Į§ń§ęĺ“≤ū§Ļ§Ž°£
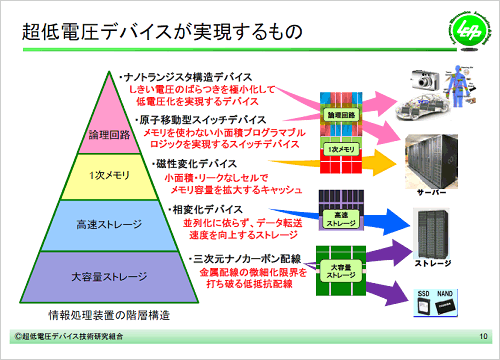
Ņř1°°LEAP§¨Ő‹Ľō§Ļń„ĺ√»ŮŇŇőŌ•∑•Ļ•∆•ŗłĢ§Ī•«•–•§•Ļ°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
»Į…ŧ∑§Ņ§ő§Ō°Ę§≥§ő•◊•Ū•ł•ß•Į•»§ÚŅšŅ §Ļ§Žń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ°ĘńŐĺőLEAP§«§Ę§Ž°£IEDM§«§Ō°Ęľßņ≠§ÚÕÝÕ—§Ļ§ŽMRAM§ő∆…§ŖĹ–§∑≤ůŌ©§ÚĻ©…◊§∑1, 0§ő•ř°ľ•ł•ů§ÚĻ≠§≤§ŽĽÓ§Ŗ§š°Ę∑ŽĺĹĻŬ§§ő —≤ŧÚÕÝÕ—§Ļ§ŽŃÍ —≤Ĺ•Š•‚•ÍPCRAM°Ęł∂Ľ“į‹∆į§ÚÕÝÕ—§Ļ§Ž•◊•Ū•į•ť•ř•÷•Ž•«•–•§•Ļ•Ľ•Ž§ő ›Ľż∆√ņ≠§ő≤ĢŃĪ§ §…§ň§ń§§§∆»Į…ŧ∑§Ņ°£§≥§ő≤∆°ĘIEEEľÁļҧőVLSI Symposium§«§őņģ≤Ő(Ľ≤ĻÕĽŮőŃ1)§ę§ť§…§őńÝŇŔŅ ≤ŧ∑§Ņ§ę°Ę§ňĺ«Ňņ§ÚĻ §Ū§¶°£
LEAP§őł¶Ķś§őŃņ§§§Ō°ĘŌņÕż≤ůŌ©°Ę1ľ°•≠•„•√•∑•Ś•Š•‚•Í°ĘĻ‚¬ģ•Ļ•»•ž°ľ•ł°Ę¬ÁÕ∆őŐ•Ļ•»•ž°ľ•ł§ę§ťĻĹņģ§Ķ§ž§Ž•≥•ů•‘•Ś°ľ•Ņ•∑•Ļ•∆•ŗ(Ņř1)§ňĽ»§Ô§ž§Ž»ĺ∆≥¬ő•«•–•§•Ļ§őĺ√»ŮŇŇőŌ§Ú≤ľ§≤§Ž§≥§»§«§Ę§Ž°£•≥•ů•‘•Ś°ľ•Ņ•∑•Ļ•∆•ŗ§«§Ō°Ęĺū ů§ÚįžĽĢŇ™§ň√ý§Š§Ž•ž•ł•Ļ•Ņ° ∆įļÓ§Ō•Š•‚•Í§»∆Ī§ł°ň§¨¬ŅŅŰĽ»§Ô§ž§Ž§Ņ§Š°ĘLEAP§Ō•Š•‚•ÍľęŅ»§Ú…‘īÝ»Įņ≠§ň§Ļ§Ž§≥§»§ÚŃņ§√§∆§§§Ž°£…‘īÝ»Įņ≠•Š•‚•Í§ŌŇŇłĽ§Ú•™•’§ň§∑§∆§‚Ķ≠≤Ī§¨Ľń§Ž§ę§ť§ņ°£§Ĺ§ő…‘īÝ»Įņ≠•Š•‚•Í§őMRAM°ĘŃÍ —≤ĹRAM°ĘFPGA§őņ‹¬≥•«•–•§•Ļ§»§ §Ž•Š•‚•Í•Ľ•Ž§ §…§őľ¬Õ—≤ŧÚŐ‹Ľō§Ļ°£
§≥§ž§ť•Š•‚•Í•«•–•§•Ļ§ň∂¶ńŐ§Ļ§Ž§≥§»§Ō°Ę•–•√•Į•®•ů•…•◊•Ū•Ľ•Ļ°Ę§Ļ§ §Ô§ŃCMOS•»•ť•ů•ł•Ļ•Ņ≤ůŌ©§ÚņŬ§§∑Ĺ™§®§ŅłŚ§ő«ŘņĢĻ©ńݧő√ś§ň•Š•‚•Í•«•–•§•Ļ§ÚļÓ§ÍĻĢ§ŗ§≥§»§«§Ę§Ž°£3ľ°łĶ•Š•‚•Í§»§§§¶∑ѧڧ»§Ž§≥§»§«Ĺłņ—ŇŔ§Ú匧≤§Ž°£§∑§ę§‚°ĘŃī§∆Ľļ∂»ĶĽĹ—ŃŪĻÁł¶ĶśĹͧňņŖ√÷§Ķ§ž§∆§§§Ž300mm•¶•ß°ľ•ŌņłĽļ•ť•§•ů§ÚÕÝÕ—§Ļ§Ž°£•–•√•Į•®•ů•…•◊•Ū•Ľ•Ļ§ÚÕÝÕ—§∑§∆ĽÓļÓ§∑§Ņ•Š•‚•Í§Ō65nmCMOS•◊•Ū•Ľ•Ļ§ÚĹ™§®§Ņ300mm•¶•ß°ľ•Ō匧ň∑Ńņģ§∑§Ņ°£
MRAM§Ō≤ůŌ©§őĻ©…◊§«•ř°ľ•ł•ů≥»¬Á
§ř§ļMRAM§«§Ō°Ę•»•ů•Õ•ŽņšĪÔňž§«§Ę§ŽMgO§ő∑ŽĺĹņ≠§ÚłĢ匧Ķ§Ľ§Ž§≥§»§«Ĺ٧≠īĻ§®≤ůŅۧÚ匧≤§Ž§≥§»§¨§«§≠§Ņ§»6∑Ó§ň»Į…ŧ∑§Ņ(Ľ≤ĻÕĽŮőŃ1)°£§Ķ§ť§ňMgO§ő∑ŽĺĹņ≠§Ú匧≤§Ž§Ņ§ŠMgOŃō§Ú1Ńō§ļ§ńĹŇ§Õ§∆ļÓ§Ž żň°§Ú≥ę»Į§∑§Ņ°£Ĺ٧≠īĻ§®≤ůŅۧŌ0.65V§ő•–•§•Ę•ĻŇņ§«°Ę10§ő16ĺŤ≤ů§»∂ň§Š§∆¬Ņ§§°£§≥§őSTT-MRAM§ŌMgO§Ú∂ī§ŗ∂Įľßņ≠¬ő§ő•Ļ•‘•ů§őłĢ§≠§ň§Ť§√§∆ņ‹ĻÁ§ňŅ‚ńĺ§ňőģ§ĻŇŇőģ√Õ° ńŮĻ≥√Õ°ň§ő¬Á§≠§Ķ§¨ —§Ô§Í°Ę§Ĺ§őļĻ§Ú1°Ę0§»»ĹńͧĻ§Ž°£§∑§ę§∑°Ę1°Ę0§ő•ř°ľ•ł•ů§Ō∂Ļ§§°£ő„§®§–°Ę0§őńŮĻ≥√Õ§¨1.7k¶ł§«°Ę1§ő§Ĺ§ž§¨2.8k¶ł§»2«‹ńÝŇŔ§∑§ę§ §§° Ņř2°ň°£
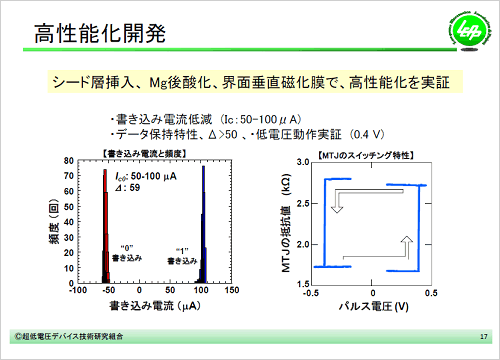
Ņř2°°STT-MRAM§őńŮĻ≥√Õ•ř°ľ•ł•ů§ŌĺĮ§ §§°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
Ļ‚Ĺłņ—•Š•‚•Í§ÚŐ‹Ľō§Ļ§Ņ§Š§ň§Ō°Ę§≥§őńŮĻ≥√Õ¬ŅĺĮ§–§ť§ń§§§∆§‚∆įļÓ§Ļ§Ž§Ť§¶§ň1°Ę0§ő•ř°ľ•ł•ů§ÚĹĹ ¨§»§ť§ §Į§∆§Ō§ §ť§ §§°£§Ĺ§≥§«•Š•‚•Í•Ľ•Ž1łń§ő∆įļÓ•ř°ľ•ł•ů§ÚĻ≠§≤§Ž§Ņ§Š§ň≤ůŌ©ņŖ∑◊§ÚŅņłÕ¬Á≥ō°Ęő©ŐŅīجÁ≥ō§ňįÕÕͧ∑§Ņ°£∆√§ň°Ę∆įļÓ•ř°ľ•ł•ů§ÚĻ≠§≤§Ž§Ņ§Š§ňŅņłÕ¬Á≥ō§Ōń„ŇŇįĶ§«§‚∆įļÓ§Ļ§Ž∆…§ŖĹ–§∑≤ůŌ©§Ú≥ę»Į§∑§Ņ°£§≥§ž§Ō∂Ļ§§ŇŇőģ√Õ° ńŮĻ≥√Õ°ň§őļĻ§ÚŇŇįĶ√Õ§ň —īĻ§Ļ§Ž≤ůŌ©§«§Ę§Ž°£∆…§ŖĹ–§∑≤ůŌ©§ňņŖ§Ī§Ņp•Ń•„•ů•Õ•ŽMOS§őīū»ń•–•§•Ę•ĻŇŇįĶ§Úńīņį§Ļ§Ž§≥§»§«…ťņ≠ńŮĻ≥≤ůŌ©° Ņř3°ň§ÚĻĹņģ§Ļ§Ž°£§≥§ő≤ůŌ©§ň§Ť§√§∆°Ę∆…§ŖĹ–§∑…ť≤ŔŇŇįĶ§Ú1§őĺžĻÁ§»0§őĺžĻÁ§»§«¬Á§≠§ĮĻ≠§≤§Ņ°£ľ¬ł≥§«§Ō°ĘŇŇőģ√Õ§ő¬Á§≠§ ĺű¬÷§Ú0.08V° ļł¬¶§őī›įű°ň°ĘŇŇőģ√Õ§őĺģ§Ķ§ ĺű¬÷§Ú0.38V(Ī¶¬¶§őī›įű)§»§Ĺ§őļĻ§ÚĻ≠§≤§Ž§≥§»§¨§«§≠§Ņ°£
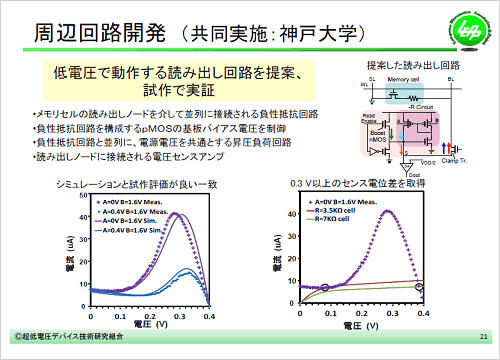
Ņř3°°ńŮĻ≥√Õ§őĺģ§Ķ§ ļĻ§Ú…ťņ≠ńŮĻ≥≤ůŌ©§«ŇŇįĶ§ň —īĻ°Ę≥»ń•§∑§Ņ°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
§Ņ§ņ§∑Őš¬Í§Ō°ĘpMOS§őīū»ń•–•§•Ę•ĻŇŇįĶ§őńīņį§¨»ýŐĮ§«°Ę…ť≤Ŕ§»§ §Ž…ťņ≠ńŮĻ≥∂ ņĢ§¨īū»ń•–•§•Ę•Ļ§ň§Ť§√§∆¬Á§≠§Į —§Ô§√§∆§∑§ř§¶§≥§»§ņ°£•Š•‚•Í•Ľ•ŽŅۧÚŃż§š§∑§ŅĽĢ§ň…ťņ≠ńŮĻ≥∂ ņĢ§ő•–•ť§ń§≠§ň§Ť§√§∆°Ę∆įļÓŇņ§¨¬Á§≠§Į —≤ŧĻ§Ž∂≤§ž§¨§Ę§Ž°£§≥§ő§Ņ§Š•Ľ•ŽŅۧÚŃż§š§Ļ°Ę§Ļ§ §Ô§ŃĻ‚Ĺłņ—≤ŧĻ§ŽĽĢ§ő•–•ť§ń§≠§Ú§…§ő§Ť§¶§ň§∑§∆łļ§ť§Ļ§ę°Ę§Ę§Ž§§§Ō§Ĺ§ő•–•ť§ń§≠§Ú§…§ő§Ť§¶§ň§∑§∆ĶŘľż§Ļ§Ž§ę°Ę§Ĺ§ő¬–ļŲ§Úłę§ń§Ī§Ž…¨Õ◊§¨Ĺ–§∆§Į§Ž°£łĹļŖ§Ō4M•”•√•»§ő•Š•‚•Í•ř•Į•Ū§ÚTEG§»§∑§∆ņŖ∑◊√ś§«§Ę§Ž°£
∑ŽĺĹA-∑ŽĺĹB§őŃęį‹§ÚÕÝÕ—§Ļ§ŽŃÍ —≤Ĺ•Š•‚•Í
ŃÍ —≤Ĺ•Š•‚•Í§Ō°ĘĹĺÕŤ•ę•Ž•≥•≤• •§•…∑Ō§őGeSbTeļŗőѧڕŔ°ľ•Ļ§ň§∑§Ņ≥ę»Į§¨¬Ņ§ę§√§Ņ°£∑Žĺŧ»»ů∑Žĺŧőĺű¬÷§ÚŃęį‹§Ļ§Ž§≥§»§«•ę•Ž•≥•≤• •§•…ńŮĻ≥√Õ§ő —≤ŧÚ1°Ę0§ň¬–ĪĢ§Ķ§Ľ§∆§§§Ņ°£ļ£≤ů°ĘLEAP§Ō∑ŽĺĹĺű¬÷AĘő∑ŽĺĹĺű¬÷B§»§§§¶Ńęį‹ĺű¬÷§ÚĻ‚ńŮĻ≥° 1°ň°Ęń„ńŮĻ≥° 0°ň§ň¬–ĪĢ§Ķ§Ľ§Ž° Ņř4°ň§≥§»§«°Ęń„ńŮĻ≥§»Ļ‚ńŮĻ≥§őĺű¬÷§Ú300«‹§‚ —§®§Ž§≥§»§¨§«§≠§Ņ° Ņř5°ň匧ň°Ę•Ľ•√•»/•Í•Ľ•√•»ŇŇįĶ§ÚĹĺÕŤ§ő1.3V/1.5V§ę§ť∂¶§ň1V/1V§ō§»≤ľ§≤§Ž§≥§»§¨§«§≠§Ņ°£•Ľ•√•»/•Í•Ľ•√•»ŇŇįĶ§ő•—•Ž•Ļ…ż§Ú —§®§Ž§≥§»§«ŇŇőģ√Õ§Ú —§®§Ž§¨°Ę•Ľ•√•»ŇŇőģ§ŌĹĺÕŤ»ś1/30§ő60¶ŐA°Ę•Í•Ľ•√•»ŇŇőģ§ŌĹĺÕŤ§ő»ĺ ¨§ő1mA§»≤ľ§¨§√§Ņ°£§≥§ő∑Ž≤Ő°ĘĺĮ§ §§•®•Õ•Ž•ģ°ľ°Ę§Ļ§ §Ô§Ńń„ĺ√»ŮŇŇőŌ°¶Ļ‚¬ģ§«ŃÍ —≤ŧĶ§Ľ§Ž§≥§»§¨§«§≠§Ņ°£
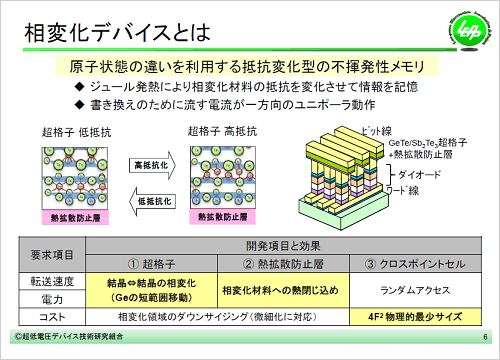
Ņř4°°ń∂≥ Ľ“∑ŽĺĹī÷§ő∑ŽĻÁĺű¬÷§őį„§§§«ń„ńŮĻ≥°¶Ļ‚ńŮĻ≥§Úņł§ŗ°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ

Ņř5°°1°Ę0§őļĻ§¨300«‹§»•ř°ľ•ł•ů§ŌĻ≠§§°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
∆ů§ń§ő∑ŽĺĹĺű¬÷§ÚļÓ§ÍĹ–§Ļ§Ņ§Š§ňGeTe/Sb2Te3ń∂≥ Ľ“ĻŬ§§Ú∑Ńņģ§∑§Ņ°£ń∂≥ Ľ“ĻŬ§§őGeTeŃō§»Sb2Te3Ńō§ÚGeł∂Ľ“§¨Ļ‘§≠ÕŤ§Ļ§Ž§≥§»§«ńŮĻ≥√Õ§Ú —§®§Ž§»§§§¶§‚§ő§«°Ę∂¶§ň∑Žĺŧ«§Ę§Ž§Ņ§ŠĻ‘§≠ÕŤ§Ļ§Ž•®•Õ•Ž•ģ°ľ§¨ĺĮ§ §Į§∆§‚ļ—§ŗ°£≤√§®§∆°ĘĺĮ§ §§ŇŇőģ§«ņł§ł§Ņ«ģ§ÚÕ≠łķ§ňĽ»§¶§Ņ§Š§ň«ģ≥»Ľ∂ň…ĽŖŃō§‚∆≥∆Ģ§∑§Ņ°£
§Ķ§ť§ň°Ę•Š•‚•Í•Ľ•Ž§ÚŃ™¬Ú§Ļ§Ž•«•–•§•Ļ§»§∑§∆pin•ņ•§•™°ľ•…§ÚŃ™¬Ú§∑§Ņ°£§≥§ž§Ō•Ľ•√•»/•Í•Ľ•√•»ŇŇįĶ∂¶§ň•◊•ť•Ļ§ő•—•Ž•Ļ§ÚĽ»§¶§≥§»§»°ĘĹń§ő«ŘņĢ żłĢ§ňĹłņ—§«§≠§Ž§ę§ť§ņ°£•”•√•»ņĢ§»•Ô°ľ•…ņĢ§ő•ř•»•Í•Į•Ļ§ő•ť•§•ů§Ú•Ę•Į•∆•£•÷§ň§Ļ§Ž§≥§»§«•ņ•§•™°ľ•…§™§Ť§”ńĺőůņ‹¬≥§Ķ§ž§Ņ•Š•‚•Í•Ľ•Ž§ÚŃ™¬Ú§Ļ§Ž§≥§»§¨§«§≠°Ę•Š•‚•Í•ř•»•Í•Į•Ļ≤ůŌ©§Úī ő¨≤ŧ«§≠§Ž°£
FPGA§ő•Š•‚•Í…Ű ¨§Úį¬ńÍ≤Ĺ
FPGA•Ū•ł•√•Į•«•–•§•Ļ§ň…¨Õ◊§ ŌņÕżņ‹¬≥Õ—§ő•Ļ•§•√•Ń§»§∑§∆°ĘĹĺÕŤ§ŌSRAM§ÚĽ»§√§∆§§§Ņ°£SRAM§Ōīūň‹Ň™§ň•’•Í•√•◊•’•Ū•√•◊ĻŬ§§Úļő§Ž§Ņ§Š°ĘĻ‚¬ģ§ņ§¨ŐŐņ—§¨¬Á§≠§§°£LEAP§ŌSRAM§ő¬Ś§Ô§Í§ňł∂Ľ“į‹∆į•Ļ•§•√•Ń§Ú≥ę»Į§∑§∆§§§Ž°£§≥§ž§ŌĽ≤ĻÕĽŮőŃ1§«ĺ“≤ū§∑§Ņ§Ť§¶§ň°ĘRuŇŇ∂ň§»CuŇŇ∂ň§«§Ō§Ķ§ř§ž§Ņł«¬őŇŇ≤ھѧő√ś§ÚŇŇ∂ň§ę§ťCu•§•™•ů§Úį‹∆į§Ķ§Ľ°ĘŇŇ∂ňī÷§Ú§ń§ §§§«§∑§ř§™§¶§»§§§¶»ĮŃاņ°£ļ£≤ů§Ō°Ę•Ľ•√•»/•Í•Ľ•√•»ŇŇįĶ§Ú∂—įž§ňņ©łś§«§≠§ŽĶĽĹ—§Ú≥őő©§∑§Ņ§Ņ§Š°Ę3°Ŗ3§ő•Ū•ł•√•Į•Ľ•Ž§ÚĽÓļÓ§∑§Ņ°£§Ń§ §Ŗ§ň•Ļ•§•√•Ń§ő§∑§≠§§ŇŇįĶ§Ō°Ę1024łń§ő•Ļ•§•√•Ń§ÚĽÓļÓ§∑°Ę√śĪŻ√Õ1.8V§«…łĹŗ –ļĻ§¨0.2V§»§§§¶∑Ž≤Ő§ņ§√§Ņ°£•™•ů/•™•’ĽĢ§őŇŇőģ√Õ§Ō§Ř§‹4.5∑Ś§»§§§¶ĹĹ ¨§ ļĻ§¨§Ę§Ž°£
ł∂Ľ“į‹∆į•Ļ•§•√•Ń§Ō°Ę1000≤ůńÝŇŔ§őĹ٧≠īĻ§®≤ůŅۧ¨∆ņ§ť§ž§∆§§§Ž§¨°Ę•Ū•ł•√•Į•«•–•§•Ļ§»§∑§∆§ŌĹĹ ¨§ ≤ůŅۧ«§Ę§Ž°£§Ņ§ņ§∑°ĘĶ≠≤Ī§∑¬≥§Ī§Ž ›Ľż∆√ņ≠§‚≥ő ›§∑§∆§§§Į…¨Õ◊§¨§Ę§Ž°£∆√§ň•™•ůĺű¬÷§«Cuł∂Ľ“§¨§ń§ §¨§√§∆§§§Žĺű¬÷§¨ ݧž§∆§§§Ī§–őŰ≤ŧĻ§Ž§Ņ§Š°Ę§Ĺ§ő¬–ļŲ§»§∑§∆CuŇŇ∂ň§»RuŇŇ∂ň§Ú∂¶§ňĻÁ∂‚≤ŧ∑°Ę«ģŇ™į¬ńÍņ≠§»Cu§ő≥»Ľ∂•–•Í•š§ÚņŖ§Ī§Ņ°£RuŇŇ∂ň§ŌTa§»ĻÁ∂‚≤ŧ∑§Ņ° Ņř6°ň°£
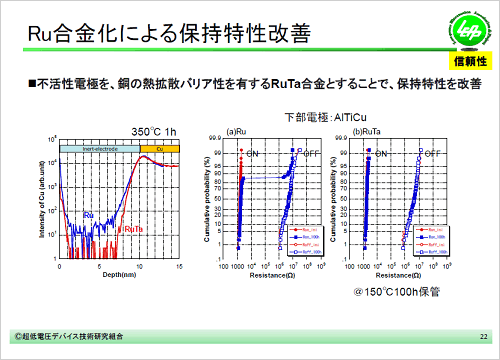
Ņř6°°RuĻÁ∂‚≤ŧ«•–•ť§ń§≠§Úń„łļ°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
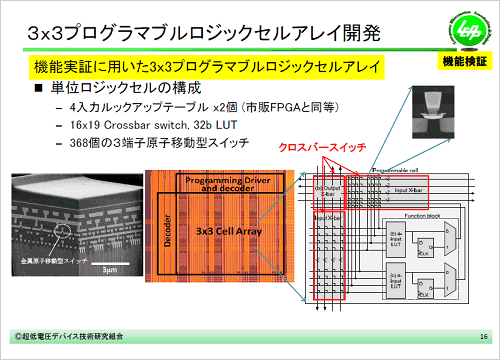
Ņř7°°•Ž•√•Į•Ę•√•◊•∆°ľ•÷•Ž§ÚĹłņ—§∑§Ņ•Ū•ł•√•Į•Ľ•Ž•Ę•ž•§°°Ĺ–ŇĶ°ßń∂ń„ŇŇįĶ•«•–•§•ĻĶĽĹ—ł¶ĶśŃ»ĻÁ
√ĪįŐ•Ū•ł•√•Į•Ľ•Ž•Ę•ž•§° Ņř7°ň§ň§Ō°Ę4∆ĢőŌ32•”•√•»§ő•Ž•√•Į•Ę•√•◊•∆°ľ•÷•Ž° LUT°ň§Ú2łń°Ę16°Ŗ19§ő∆ĢőŌ§™§Ť§”Ĺ–őŌ•Į•Ū•Ļ•–°ľ•Ļ•§•√•Ń°ĘD∑Ņ•’•Í•√•◊•’•Ū•√•◊2łń§ §…§ÚĹłņ—§∑§∆§™§Í°Ęł∂Ľ“į‹∆į•Ļ•§•√•Ń§Ō368łńīř§ř§ž§∆§§§Ž°£§≥§ő√ĪįŐ•Ū•ł•√•Į•Ľ•Ž§Ú3°Ŗ3§ő•ř•»•Í•Į•Ļ•Ę•ž•§ĻĹņģ§ň§∑°Ę§Ķ§ť§ň•Ľ•Ž§Ú•Ę•…•ž•Ļ§Ļ§Ž§Ņ§Š§ő•«•≥°ľ•ņ§š•…•ť•§•–§Ú§Ĺ§ž§ĺ§žX°ĘY§ň«Ř√÷§∑°Ę∆įļÓ§Úł°ĺŕ§∑§Ņ°£
§Ķ§ť§ň6°Ŗ6ĻĹņģ§ő•Ū•ł•√•Į•Ľ•Ž•Ę•ž•§§ő•ž•§•Ę•¶•»§Úł°∆§§∑§∆§™§Í°ĘTEG•ž•Ŕ•Ž§«SRAM§»»ś§Ŕ68%ŐŐņ—ļÔłļłķ≤Ő§Ú≥ő«ß§∑§∆§§§Ž°£ļ£łŚ§Ōľ¬ļ›§ňĽÓļÓ§∑°Ę§Ĺ§őłķ≤Ő§Úł°ĺŕ§Ļ§Ž°£
Ľ≤ĻÕĽŮőŃ
1. LEAP°ĘLSIĺ√»ŮŇŇőŌļÔłļ§ő§Ņ§ŠMOS§ő≠ýVtļÔłļ°Ę…‘īÝ»Įņ≠•Š•‚•Í§ňőŌŇņ (2012/06/15)

