IGBTの高速化に向け2種類のイオン注入装置をアルバックが発売
半導体製造装置もニッチ市場で勝負する時代といえそうだ。アルバックは、IGBTパワー半導体に特化した加速エネルギーが2keV〜30keVと低い加速電圧と、最大2400keVと極めて高い加速電圧の2種類のイオン注入装置を発売する。それぞれ浅い、深いpn接合を作るのに使う、両極端のニッチ向け装置だ(図1)。

図1 アルバックが発売する低加速(左)・高加速(右)のイオン注入機 出典:アルバック
この装置の背景にあるのはIGBTである。昨今、SiCやGaNなど新しいワイドギャップトランジスタが登場し、IGBTを片隅に追いやろうとしているが、IGBTも欠点を克服し生き残りを図る。SiのIGBTの最大のメリットはSiCなどと比べて価格の安いこと。このためSiCは実のところ苦戦を強いられており、その間にIGBTは欠点を克服しようとしている。
IGBTの欠点は何といってもSiCやGaNのMOSFETと比べて動作速度が遅いこと。その構造がnチャンネルMOSFETのドレインN+層にさらにP+層を追加してバイポーラ(電子と正孔の二つのキャリア極性)を利用して電流を増やせるようになっている。反面、動作状態(オン)から電流を止めるオフ状態に切り替えると、N-層に注入された正孔がいつまでも残っていてなかなか消えずにテール電流として存在するため、スイッチング速度を上げられない、という欠点がある。いわゆる少数キャリヤの蓄積時間が長い。そこで、その時間を短縮するため、正孔がすぐに電子と再結合して消えるようにライフタムキラーを入れる。銅などの重金属は半導体中にキャリヤを捕獲するトラップ準位を発生するが、電子とすぐに再結合して電気抵抗が上がってしまうという欠点がある。そこで水素やHeのような元素をイオン注入してSi結晶の一部を壊し欠陥を意図的に作り、トラップ準位を形成するのである。
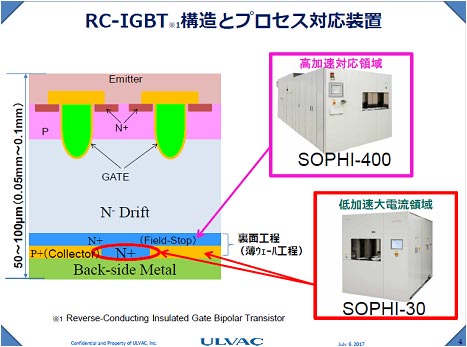
図2 最新のIGBTのトランジスタ構造と今回のイオン注入機の用途 出典:アルバック
水素は、N+層の不純物プロファイルと同様にイオン打ち込みし、300〜400°Cの低温で活性化させると、N+ドーパントとして機能するらしい。デンソーの特許情報によると(参考資料1)、N+層の不純物プロファイルと水素原子のプロファイルを揃える(厳密にはプロファイルの半値幅を揃える)ことによって、リーク電流も減るという。最近では、IGBT構造のp型コレクタ領域を基板とするのではなく、N-層を基板とすることが多い。ここに裏面からB(ボロン)を注入してp型コレクタを形成しさらにN+フィールドストップ層を形成する構造が主流になっているという(図2)。そのためには表面の電界効果トランジスタ領域が完成した後で、N-基板を100µm程度まで削り、裏面側にP+/N+層を形成することになる。表面にAl電極がすでに形成されているため、低温で形成せざるを得ない。裏面電極はもちろん最後に形成。
アルバックが今回発売するニッチのイオン注入装置は、IGBTの裏面のP+/N+層を形成するための二つの装置である。
低加速電圧の「SOPHI-30」は、P+層の浅い接合を形成するための枚葉式装置。枚葉式にしたのは、従来のような複数枚のウェーハを大きなディスクに張り付けて回転される方式だと、100µmのような薄いウェーハだとハンドリングが難しくが割れる恐れがあるからだ。また、従来のイオン注入装置は、イオン源からウェーハまでの距離が長く、ビームが広がってしまいウェーハ面での電流を大きく取れなかった。低加速専用だと、加速するための距離を長くする必要がない。従来機だとイオン源からウェーハまでの距離が6mもあったが、今回は50cmに短縮した。この結果、床面積も従来の1/3と小さくなり、2×10の15乗イオン/cm2の電流で打ち込むのに、従来の10分から10秒ですむようになった。
高加速電圧の「SOPHI-400」は、N+層を形成するのにPや水素の打ち込みに使う。PN接合の空乏層が無駄に広がらずに損失を減らすためのフィールドストップN+層を裏面から形成するためには2400keV (2.4MeV)という高い加速電圧でのイオン注入が求められている。ここも極薄ウェーハでの処理のため枚葉式を採用し、深いN+層を形成する。N+層に水素を打ち込むと、他のドーパントよりも原子半径が小さいため深くまで届く。このため約4µmの深さのプロファイルができるとしている。N+注入は低温では活性化しないため、レーザーアニールを使うが、水素は350〜400°Cのファーネスでアニールできる。
イオン注入装置は高電圧を使うため、装置そのものにIGBTやSiCを使うことが多い。アルバックの今回の装置も加速電源だけではなく周囲の磁石用の電源など多くの電源を使っており、しかも高耐圧が必要となるため、IGBTやSiCダイオードを使って装置の小型化に寄与しているという。
参考資料
1. 特許「絶縁ゲートバイポーラトランジスタおよびその製造方法」、デンソー、合田健太、出願日2014年10月6日、公開日2015年5月21日


