ムーアの法則を終焉させず1nm以下めざす本気のimec、撤退した日本勢
ベルギーの半導体・ナノテク研究機関imec CEO兼プレジデントのLuc Van den hove氏は、同社と蘭ASMLが密接に協業して次世代高解像度リソグラフィ技術である高NA EUV(極端紫外線)リソグラフィ技術を実用化することで、ムーアの法則を終焉させることなく、微細化を1nm以降も継続させると宣言した(図1)。 これは、11月18日にバーチャルオンラインで開催されたimec主催の 年次研究紹介イベントimec Technology Forum (ITF) Japan2020の冒頭、同氏が研究の全体像を紹介する基調講演の中で述べたもの。

図1 「ムーアの法則は終焉しない」imec Technology Forum Japan 2020で講演するimec CEO兼プレジデントのLuc Van den hove氏
(出所:著者がPC画面をスクリーンショット)
更なる微細化から撤退していった日本勢は競争力失いリストラの嵐
かつてSEAJ主催の半導体産業動向に関する講演会で、著名な半導体事業責任者や大学教授が口をそろえて「45/40nm以降の28nm以降へ向けたロジックデバイスの微細化は、コスト高になるだけで採算が合わないからやるべきではない」と主張し、実際、日本の全ての半導体メーカーは45/40nm以降のロジックデバイス製造から撤退してしまった。半導体専門誌も「ムーアの法則の終焉」といった特集記事を組んでこの動きを報じたが、そんな雑誌も半導体技術者の減少で部数減に悩まされすべて廃刊に追い込まれた。
その余波が未だに残っていて、競争力を失った日本の半導体業界のプロセス技術者のリストラが延々と続いている。つい最近も、パナソニックは半導体事業から完全撤退した。タワーセミコンダクタが51%の株式を持つTPSCo(Tower Jazz Panasonic Semiconductor Co., Ltd)の北陸3工場(パナソニックが49%の分)を台湾勢に売却してしまい、同じTPSCoでもTower Partners Semiconductor Co)と名乗っている。東芝デバイス&ストレージ社は、システムLSI事業撤退に伴い770人がリストラされつつある。さらには旧東芝大分工場と旧岩手東芝エレクトロニクス(現在はジャパンセミコンダクターという名の工場。ファウンドリビジネスと称していたが営業活動はなし)の売却話も持ち上がっている。
超微細化に必須のEUV露光技術についても、日本の露光装置メーカートップは「技術的には優れているが、筋が悪く実用化するわけがなく、まるでコンコルド(早々と退役し普及しなかった超音速旅客機)のようだ」といってEUV露光装置も開発段階で撤退してしまった。そしてかつて露光技術で世界を制覇していた日本勢は、いつの間にかシェア1桁へ転落してしまっている。ニコンは、主力のカメラ事業に加えて、半導体露光装置事業も不振で大幅な人材」リストラを行うという。
ムーアの法則に従い超微細化の道を切り開いた者だけが勝ち残る
ムーアの法則終焉の話は、実は32/28nm世代になってはじめて言われたわけではなく、ずーっと以前から繰り返しいわれてきたが、終焉と判断した人たちが脱落していっただけで、ポジティブな見方で真剣に取り組んだ人たちによって超微細化の道が切り開かれてきた。
かつて半導体産業とは無縁のベルギーの片田舎の研究所だったimecは、終始一貫ムーアの法則の延命に真剣に取り組み、今や世界最先端の最大かつ最高の半導体微細化研究機関へと成長した。
先端半導体業界では、台TSMCと韓Samsungが、7/5nmデバイス量産に EUVリソグラフィ(NA=0.33)を適用している。TSMCでは、去る11月に台湾の3nm量産ファブが竣工し、本社のある新竹にて2nm量産ファブの建設を準備中で、ASMLに1台200億円前後のEUV露光装置を多数発注している。TSMCによれば、利益の最大の源泉は超微細化プロセスによる製造受注にあるという。同社の今年の売上高は前年比3割増と予測されている。
imecとASMLが高NA EUVラボを設立、超微細化の研究に着手
Van den hove氏は講演の中で、微細化が3nmの壁を越えると、さらに高解像度の次世代高NA (NA=0.55) EUV装置を導入する必要があると指摘した(図2)。ASMLでは、すでに巨大な高NA EUV露光装置(NXE:5000シリーズ)の基本設計を終えているが、商品化は2022年ごろの予定であるという。ASMLは従来からimecと密接に協業してリソグラフィ技術開発を行ってきたが、高NA EUVリソグラフィ装置を用いたリソグラフィプロセス開発に関しては、ベルギーのimecキャンパスに「IMEC-ASML HIGH NA EUV LAB」を新たに設置して共同開発を行い、マスクやレジストの開発なども両社が素材サプライヤと一緒になって開発を行うとしている。
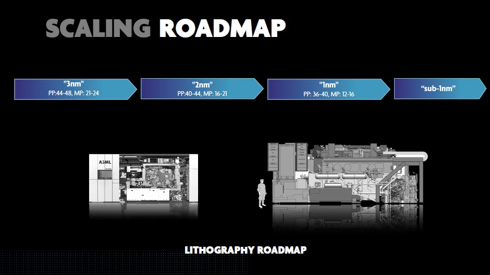
図2 3nmから1nm未満に至るリソグラフィ装置のロードマップ:従来型(NA=0.33)EUV露光装置から巨大な高NA (NA=0.55) EUV露光装置へ (出所:imec. 2020年11月)
EUV露光は日本生まれの技術なのに日本で半導体製造に使われない
EUVリソグラフィは、実は日本生まれの技術であることは、ほとんど忘れ去られている。世界ではじめてのEUVリソグラフィの発表は、1986年応用物理学会秋季大会でのNTTによる「X線縮小投影露光」と題する発表であることはASMLも認めている。その後、従来のX線リソグラフィと区別するため、米国でEUVリソグラフィと呼ばれるようになった(参考資料1)。いわば本家の日本では、20年近くにわたり、巨額な研究費を投じてEUV関連のさまざまな国家プロジェクトや業界コンソーシアム活動が行われたが、結局、日本の装置メーカーはEUV露光装置開発から早々と撤退し、EUV露光を生産に活用する半導体メーカーも皆無のありさまだ。実は、EUVのみならず、すべての半導体関連の国家プロジェクトやコンソーシアム活動が、目標に掲げていた「日の丸半導体の復権」をもたらさなかった。
国家予算を使って海外の半導体メーカーを日本に誘致したり、日の丸ファウンドリを設立したりしようという動きがあるようだが、そんな思い付きのような試みは決して成功しないだろう。その前に日本の「失敗の本質」、海外勢の「成功の本質」をきちんと学ぶべきだろう。
参考資料
1. 服部毅:「ムーアの法則を継続させる3D実装とEUVリソグラフィ技術」、マイナビニュース、(2020/07/22)


