Selete§¨Low-kňž§ő•®•√•Ń•ů•į§ňCH3I•¨•Ļ§őÕ≠łķņ≠§Úľ¬ĺŕ
Selete (»ĺ∆≥¬őņŤ√ľ•∆•Į•ő•Ū•ł°ľ•ļ)§ő¬Ť∆ůł¶Ķś…ۧŌ°ĘLow-k/Cu«ŘņĢĶĽĹ—§ő≥ę»Į§ÚŅ §Š§∆§§§Ž§¨°ĘĶ°≥£Ň™§ň§‚§Ū§§Low-kňž§Ō•Ō°ľ•’•‘•√•Ń(hp)45nmį ĻŖ§ő•◊•Ū•Ľ•Ļ§«°Ę•®•√•Ń•ů•į∑Ńĺű°ĘĻ‚Ń™¬Ú»ś°Ę•ņ•Š°ľ•ł•’•Í°ľ°Ęń„īń∂≠…ť≤Ŕ°Ę§»§§§√§ŅŐš¬Í§Ú•Į•Í•š°ľ§∑§ §Į§∆§Ō§ §ť§ §§°£§≥§ő§Ř§…Ņ∑§∑§§•®•√•Ń•ů•į•¨•Ļ§»§∑§∆CF3I§¨§≥§ž§ť§ÚňĢ¬≠§Ķ§Ľ§Ž§≥§»§Ú∆Īľ“§ŌSelete Symposium2008§«Őņ§ť§ę§ň§∑§Ņ°£
CF3I§Ō°ĘF•ť•ł•ę•Ž§¨»Įņł§∑§ň§Į§Į°Ę§Ĺ§őŐ©ŇŔ§Ō»ůĺÔ§ňń„§§° ≤ľ§őŅř§őŅŅ§ů√ś°ň°£•ņ•Š°ľ•ł§ÚÕŅ§®§ŽĽÁ≥įņĢ° UV°ň∂ĮŇŔ§‚C4F6§šCF4§ §…§»»ś§Ŕ§∆§‚ń„§§° ≤ľ§őŅř§őļł°ň°£≤√§®§∆°Ę√ŌĶŚ§ő≤Ļ√»≤ŧň§‚§š§Ķ§∑§§°£√ŌĶŚ≤Ļ√»≤Ĺ∑łŅŰ° GWP: global warm potential°ň§Ōį¬ńͧ §¨§ť≤Ļ√»≤Ĺ•¨•Ļ§»§∑§∆∑ý§Ô§ž§∆§§§ŽCO2§Ú1§»§∑§∆§≥§ž§ř§«§ő•®•√•Ń•ů•į•¨•Ļ§«§Ę§ŽCF4§Ō6500«‹§‚į≠§§°£C4F8§Ō§Ķ§ť§ňį≠§Į8700«‹§‚į≠§§°£ĺĮ§ §Į§»§‚CO2§ő1§Ť§Í§Ōĺģ§Ķ§§ļŗőѧÚŃ™§”§Ņ§§°£Selete§¨ł°∆§§∑§∆§§§ŽCF3I•¨•Ļ§Ō1Ő§ňĢ§«§Ę§Ž§»§§§¶(≤ľ§őŅř§őĪ¶)°£
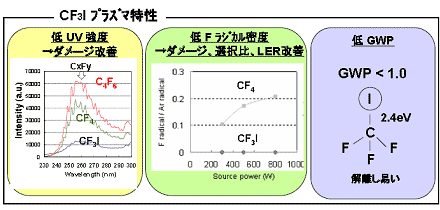
§≥§≥§«Õ—§§§∆§§§ŽLow-kňž§Ō•›°ľ•ť•Ļ§ SiOC° k=2.6°ň§«§Ę§Í°ĘĶ°≥£Ň™§ ∂ĮŇŔ§¨ľŚ§Į°Ę•◊•ť•ļ•ř§ň§Ť§Ž¬ĽĹż§ň§‚ľŚ§§°£§Ĺ§ž§«°ĘLow-kňž§ň•≠•„•√•◊Ńō§Ú»Ô§Ľ§∆§ę§ť45nm•ő°ľ•…§ő«ŘņĢ•—•Ņ°ľ•ů§Ú»ś§Ŕ§Ž§Ņ§Š°Ę•◊•ť•ļ•ř§ň§Ť§Ž¬ĽĹż§Ú…ŧĻ•—•Ņ°ľ•ů¬¶ …§őĻ”§ž° LER:•ť•§•ů•®•√•ł•ť•’•Õ•Ļ°ň§Úńī§Ŕ§∆§Ŗ§Ž§»°ĘĹĺÕŤ§őCF4§ņ§»¬¶ …§őĻ”§ž§Ō6nmńÝŇŔ§Ę§√§Ņ§‚§ő§¨°Ęļ£≤ů§őCF3I§«§Ō2nm§»łļĺĮ§∑§Ņ°£§Ļ§ §Ô§Ń¬¶ …§Ō§≠§ž§§§ň≤√Ļ©§«§≠§∆§§§Ž°£
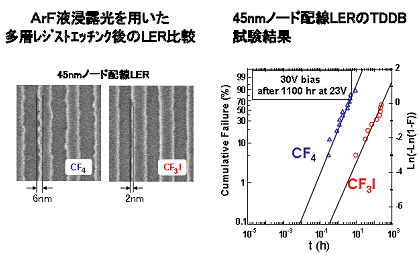
§≥§ő•®•√•Ń•ů•į•¨•Ļ§ÚĽ»§√§∆≤√Ļ©§∑§Ņ45nm•ő°ľ•…«ŘņĢ§őTDDB° time dependent dielectric breakdown°ň§őŅģÕÍņ≠§‚ńī§Ŕ§∆§Ŗ§Ž§»°Ę•Ô•§•÷•Ž ¨…ا«őŖņ—łő儧ڳ꧎§»°ĘŅģÕÍņ≠ľųŐŅ§Ō2•Ī•ŅńÝŇŔĻ‚§Į§ §√§∆§§§Ž°£
§ř§Ņ°ĘCF4§»C4F6§őņģ ¨»ś§Ú —§®§Ž§≥§»§«•®•√•Ń•ů•į•¨•Ļ§őŃ™¬Ú»ś§»LER§»§¨•»•ž°ľ•…•™•’§őīō∑ł§¨§Ę§√§Ņ§‚§ő§ő°ĘCF3I§ŌĻ‚§§Ń™¬Ú»ś§»ń„§§•◊•ť•ļ•ř¬ĽĹż§Úőĺő©§«§≠§Ņ§»§∑§∆§§§Ž°£

