先端パッケージの3D-ICパッケージングの低温実装を推進するコネクテック
先端パッケージ技術が次世代の高集積化技術として注目されている。チップレットや3次元ICのパッケージングでは、これまでとは異なる技術が求められる。研究開発向け半導体チップのパッケージングを手掛けるコネクテックジャパンがインプリント法で10µmピッチの電極を形成する技術や、80°Cで半田バンプをチップ接続する技術で受注を獲得し続けている(図1)。

図1 これまでの受託実績 上場していないため売上額を公表できないが伸びているようだ 出典:コネクテックジャパン
新潟県妙高市に本社を構えるコネクテックは社員数42名の中小企業ながら、これまでの受託実績は300社を超える見込みで、2022年度には41件以上が見込まれている。顧客数も60社以上獲得している。またビジネスモデルとして汎用量産品は扱わないが、研究開発向けにカスタム対応でパッケージングすることで、自社をOSATではなく、OSRDA(Outsourced Semiconductor R&D Assembly and Test)と称している。
コネクテックが持つ強い先端パッケージ技術には、代表的なものとして二つある。一つは2019年にセミコンポータルで紹介した、80°Cで電極パッド同士を接続できる技術であり(参考資料1)、もう一つは最小10µmピッチと微細な電極ピラーを成型できるインプリント技術である。さらにNTTが発表している将来のIOWN構想に対応してシリコンフォトニクス技術による実装も提案している。
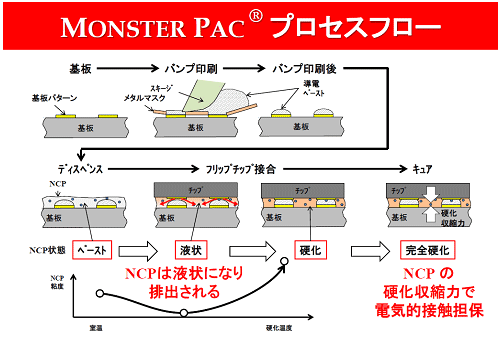
図2 80°Cでフリップチップ実装するプロセスフロー 出典:コネクテックジャパン
まず80°Cでチップ上の電極を基板上の電極に接続する技術では、ネプコンジャパン2023でその詳細を示した。図2に示すように、導電ペーストをスクリーン印刷によって基板上の回路パターンの電極部分にスキージを使って塗っていく。その上にペースト状の非電導性接着剤NCPを基板全面に塗りその上からチップの電極と合わせるように搭載する。室温から温度を上げていくと、NCPはペースト状から液状になり電極面同士間でははみ出して流れ出ていく。さらに温度を上げるとNCPは硬化する。その硬化温度を80度まで下げることができた。さらにキュアすると電極間に隙間なく入り込んだNCPがアンダーフィルとして埋めることになり接着性が改善する。
80°Cは今のところ下限ぎりぎりなので、リジッド基板では80〜170°Cで選べば問題ないという。また、これまで電極のボールとなる半田温度260°Cで接着していたことと比べると低温で接着したことになる。しかし、80°Cで電極同士を接着できるためフレキシブルプリント回路基板にもICチップを実装できる。カギはNCPだが、その構造は明らかにしない。また、80°Cで接着できるとしても150°C程度の高温動作でも崩れないという。NCPの硬化温度が低くても固まってしまえば構造が変わってしまうためだとしている。
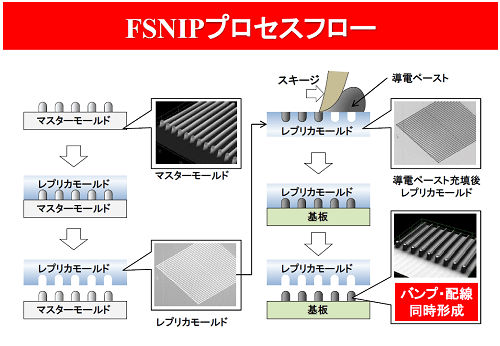
図3 10µmピッチの電極ピラーのアレイを作成するプロセスフロー 出典:コネクテックジャパン
2番目の微細な金属ピラーを形成する技術は、FSNIP(Free Substrate-material Narrow Imprinted Process)と呼ぶ。今注目を集めている2.5D/3D-IC向け先端パッケージに使う技術だ。どのような基板にもインプリント技術で電極ピラーを形成できるため、最初の言葉にFreeを用いている。ここでは電極アレイの配線ピッチを10µm、配線幅5µmまで微細にした基板を試作している。電極ピラーのアスペクト比は3以上が可能だという。その製法は、図3に示すようにインプリント技術を使う。
まず、マスターモールドを作製し、その上に樹脂を載せレプリカモールドを作る。このレプリカモールドの穴に電極となる導電ペーストをスクリーン印刷で塗る。導電ペーストの埋まった面を基板の電極面に来るように基板と接着させ、最後にレプリカモールドを外せば電極ピラーが出来上がる。
これをフリップチップでICの電極と合わせれば微細な電極の3D-IC接続が可能になる。ここに最初のNCP技術を使って80〜120°Cで処理してICチップを接続することも可能になる。量産性に関してのメリットもある。従来のFOWLP(Fan-Out Wafer Level Packaging)工程では39工程が必要で、月産100個実装する場合、設備投資額が数十億円〜100億円程度見込まれるのに対して、FSNIP法では16工程と短くて済むため、設備投資は同じ量を生産する場合でも4億円で済むという。

図4 微細な配線ピッチにも低温実装技術は使える 出典:コネクテックジャパン
ただ、この10µmの電極ピラーはまだ試作品なので、実用化は2025年と見ている(図4)。その前に20µmピッチの電極ピラーのアレイも開発しており、むしろ実用化は20µmピッチから始まるかもしれない。
さらにNTTが将来の光電技術であるIOWN構想に対応してシリコンフォトニクス技術による実装も提案している。NTTはIOWN構想の中で、現在の装置間の光ファイバ伝送やコンピュータシステム装置内のモジュール基板間の光伝送から、さらに基板内のチップ間伝送を想定したロードマップを立てているが、コネクテックはICパッケージ内のチップレット間の光伝送を目指した未来も描いている。
容易にレーザー発振器と光ファイバ間、および光ファイバと受信機の間の光軸合わせを容易にする技術にも挑戦している。チップ間やチップレット間のように配線が短く小型になればなるほど光軸合わせは難しくなる。ずれが±3µm以下の高精度なアライメント(光軸合わせ)を実現したとしているが、詳細はまだ明らかにしていない。ここでは様々な企業とのコラボで実装技術を完成させたいとしている。
参考資料
1. 「フリップチップ実装を3コースで提供するコネクテックジャパン」、セミコンポータル (2019/05/30)


