SamsungファウンドリとAmkorが2.5Dパッケージ技術を共同開発
Samsungのファウンドリ部門が最大6個のHBM(High Bandwidth Memory)メモリとプロセッサやSoCを2.5D(2.5次元)で集積するパッケージング技術をAmkorと共同で開発した。半導体ユーザーがデータセンターやAI、HPC(高性能コンピューティング)、ネットワーク製品へ参入するのを支援する。
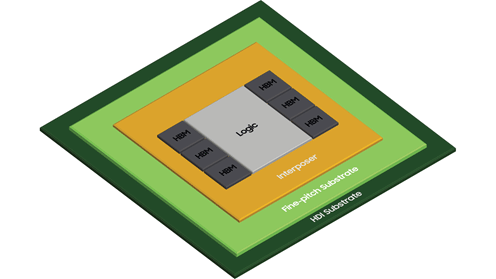
図1 HBMを最大6個まで搭載できるハイエンドSoCパッケージング技術 出典:Samsung
最近のハイエンドコンピュータ向けチップは、4個のHBMをインターポーザ上に集積した製品が多く、Appleの MacBookのCPUとなるチップや、Nokiaのネットワークプロセッサ、AMDのチップレット利用のプロセッサなど軒並み、SoCを中心に配置し、その周囲にHBMを置くという構成が増えている。SoCにはCPUとGPUが集積されているため、それらのデータメモリをHBMで共有でき、システム速度が格段に上がるというメリットがあるからだ。
AppleやNokia のチップではHBMが4個の構成だったが(参考資料1、2)、SamsungとAmkorのグループは最大6個まで搭載できることを訴求している。
SamsungがH-Cube(Hybrid-Substrate Cube)と呼ぶこの技術は、CPUとGPUなどの他のプロセッサを集積したSoCでは、CPUとGPUのメモリを共有している方が、していない場合と比べて速度が全く違う。CPUからGPUへ命令を出してGPUのメモリとGPUとのやり取りを経た後CPUにそのメモリデータを送り、さらにCPUのメモリへ送るという手間を省くことができるからだ。メモリをCPUとGPUなどと共有していれば、演算結果を素早くCPUに送ることができる。このためにはメモリの同一性(コヒーレンシ)が求められる。広いバンド幅のHBMで大量のメモリをCPUと送受信できれば極めて高速になる。
この2.5D製品は図2のように、SoCとHBMを6個、インターポーザを通して接続しており、1パッケージにSoCとHBMメモリを搭載した形になる(参考資料3)。さらにファインピッチサブストレートを経てHDI(High Density Interconnection)基板に落とし、最終的なICパッケージとなる。ここではハンダバンプの大きさを少しずつ拡大しながら、プリント回路基板に実装するICパッケージに仕上げている。接続には全てハンダボールを使っている。
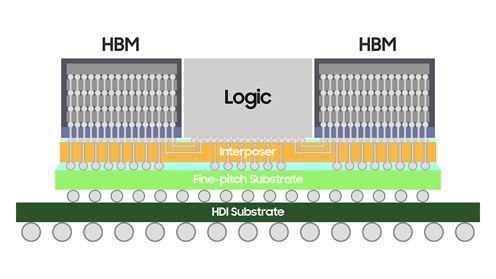
図2 インターポーザを通してSoCとメモリを接続 出典:Samsung
今後、データセンターやAI、スーパーコンピュータなどのHPC、5Gコア基地局のネットワークプロセッサなどハイエンドな製品が欲しいユーザーに向け、パッケージングサービスを提供できるようになる。実際にはAmkorが提供するのかSamsungなのかは明らかにしていない。
参考資料
1. 「Appleの新型SoC、GPU・ビデオ機能を充実しながら消費電力を削減」、セミコンポータル (2021/10/20)
2. 「『独自チップは脱炭素を実行する上で不可欠』Nokia、新プロセッサ開発の理由」、セミコンポータル (2021/10/14)
3. "Samsung Announces Availability of Its Leading-Edge 2.5D Integration ‘H-Cube’ Solution for High Performance Applications", Samsung Newsroom (2021/11/11)


