EIDEC、グローバル協力で10nm台の加工にEUV導入目指す(2)〜マスク検査
EUVは物質を透過しやすいX線の一種であるため、光学系にはレンズではなく反射板を利用する。反射光学系のマスクブランクスは、W/Moの繰り返し積層構造を採っている。ここに欠陥が入るとパターンが歪んでしまうため、無欠陥にしたい。マスク検査は不可欠である。
マスクブランクスにEUV光を当てて欠陥を見るABI(Actinic Blanks defect Inspection)検査装置をEIDECプロジェクトが始まる前のMIRAIプロジェクトで試作し、欠陥の計測技術をSeleteプロジェクトで確立した。EIDECでは量産試作機の製造に努力してきた。
EIDECでは、マスク欠陥検査装置のレーザーテック社と共同で、ABIの量産試作機を作り上げた(図4)。この量産試作装置では、高さ1.6nm、幅250nmの欠陥から、高さ1.0nm、幅33nmの欠陥まで欠陥を100%検出できている。高さ1.0nm、幅33nmはハーフピッチ(hp)16nmノードに相当するという。EUV露光システムでは4倍の縮小投影を念頭に入れているためである。
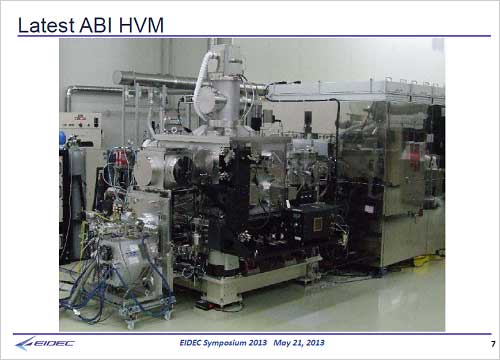
図4 ABI量産試作装置 出典:EIDEC
また、マスクブランクスに欠陥が見つかった場合でも、その上に描くパターンによっては欠陥の影響を和らげるための技術についても述べている(図5)。これは、X線の吸収体パターンの上に欠陥を持ってくるように、パターンの位置をずらす技術だ。ただし、その位置を正確に測定できる技術も必要となる。

図5 マスクブランクスの欠陥の影響を軽減する 出典:EIDEC
パターンの付いたマスクでは、その外観検査装置を荏原製作所と共同で開発した。これはプロジェクション型の電子ビームを利用した検査装置PEM(Projection Electron Microscope)である。照明用の電子ビームをパターン付きのマスクに照射し、2次電子をTDI(time delay integration)センサのCCDカメラで検出する。プロジェクションレンズを構成し、電子顕微鏡として像を見ていることになる。
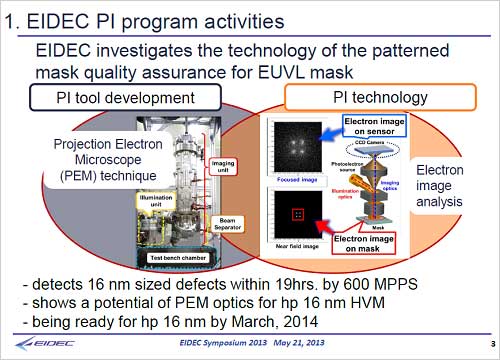
図6 PI(Patterned mask Inspection)装置の概要 出典:EIDEC
EUVマスクを電子顕微鏡で検査できるメリットの一つに、チャージアップがないことがある。ArFなど光リソの場合に使ってきたガラスマスクなどは絶縁体であるため、チャージアップすることで像がぼけるが、EUVマスクはW/Moの層構造なのでチャージアップせず、電流の制限はない。
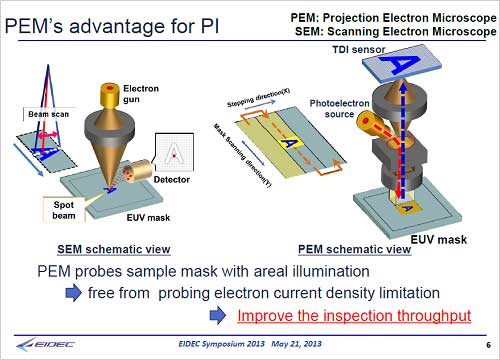
図7 電子ビームでスキャンする 出典:EIDEC
このPEM検査装置では(図7)、ステップアンドリピート方式でパターンをスキャンしていくため、スループットが高く、16nmサイズの欠陥を19時間以内に探すという目標を設定している。今のところ、hp64nmおよび44nmのL/Sパターン像を捉えることに成功している。今後は、hp16nmの欠陥観測に挑戦するが、見つけられる可能性が出てきたとしている。
(続く)
参考資料
1. EUV時代が見えてきたか、IntelがASMLと歩調を合わせ10nmに照準 (2013/05/22)
2. EIDEC、グローバル協力で10nm台の加工にEUV導入目指す(1)〜概要 (2013/05/31)
3. EIDEC、グローバル協力で10nm台の加工にEUV導入目指す(3)〜レジスト (2013/05/31)


