Applied、EUVの寸法を半減させるパターンシェイピング装置を開発
波長13.5nmのEUV(Extreme Ultra Violet)リソグラフィでもダブルパターニングが導入され始めた。ただし、解像度が30nmまでしか得られないため、位置合わせが難しい。Applied Materialsは、最小のパターン幅を安定に形成するパターンシェイピング技術を導入する装置「Centura Sculpta」を開発した。これを使えばダブルパターニングと同等な寸法を安定に形成できる。

図1 EUVのダブルパターニングと等価的に同じ寸法を実現するパターンシェイピング装置 出典:Applied Materials
現在、ロジックプロセスのファウンドリなどが5nm、3nmプロセスノードと主張しているが、配線幅/配線間隔の実寸法は30nmピッチが最も微細だという。ダブルパターニングはそのピッチを半分程度に微細化するための技術である。しかし、微細な配線になると一つの方向に向けたグレーティングパターンを増えてくるが、配線の端と向かい合った配線の端の間(tip to tip)の解像度はパターンが並んだ方向の解像度よりも必ず落ちてしまう(図2)。
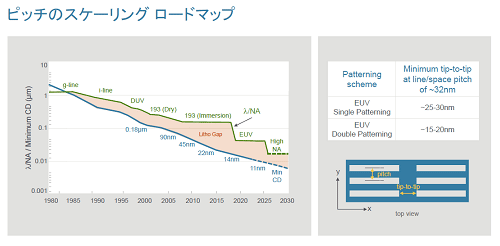
図2 グレーティングパターンのY方向より直角のX方向(パターンの端同士の距離)の解像度の方が低い 出典:Applied Materials
図2にある通り、現状のEUVのシングルパターニング技術、その向かい合ったパターンの端同士の間は25〜30nmしか形成できない。ダブルパターニングで形成できたとしても15〜20nm止まりである。ダブルパターニングでは位置合わせ誤差を小さくすることが難しく、歩留まりは極めて悪くなる。
そこで、Appliedは2回目のパターニングにリソグラフィを使わずに、プラズマエッチングでパターンを削る技術を開発した。具体的にはEUVで例えばビアホールなどのパターンを形成した後に斜め方向からプラズマリボンビームでウェーハ全面をスキャンする。プラズマで発生したイオンと中性ラジカルの混合ビームを斜めから当てることで側面を削っていく。それもウェーハを回転させ向きを調整して均一にパターンを削り取っていく(図3)。
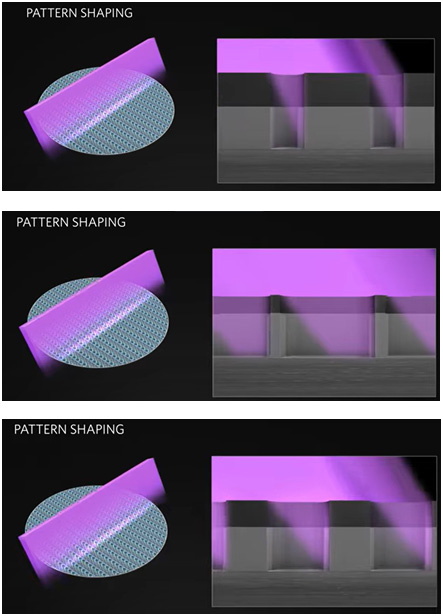
図3 プラズマビームを斜めから照射することで、パターンの側壁を削りパターンを細くする(上図から下図へ) 出典:Applied Materialsのビデオ
この方法であれば、EUVリソグラフィは1回で済み、投資コストは安くなるとともに製造コストも安くなるという。パターニングはEUVを使うよりも簡単になるためだ。この結果、EUV装置の消費電力はかなり大きいため、電力およびそのコストの削減につながりCO2削減にもなる。
プラズマビームで削り取るこの方法は、ビームの向きやビーム強度(プラズマ密度など)、角度、スキャン速度などで制御する。エッチングを時間で制御する概念に似ている。Applied Materialsは、EUVダブルパターニングにとって代わる技術になりうると期待している。


