インフィニオン、カーエレ用パワー半導体の新パッケージ技術を明らかに
カーエレクトロニクスに搭載するパワーMOSFETをリードレスパッケージに収容しても200Aを流すことのできる実装技術を、インフィニオンが明らかにした。これまでのD2PAK型パッケージでは180Aが最大電流だったが、新開発のTO-LL表面実装型パッケージは200Aまで流せることで、インバータの小型化につながる。

図1 Infineon社Package Concept & Definition部門シニアスタッフスペシャリストのStefan Macheiner氏
「カーエレの分野では、1ppm(100万分の一)の不良率でさえ不十分。限りなくゼロにしなくてはならない。半導体の不良率が1ppmでも、クルマに使われている半導体は1万5000個(平均)もあるから、クルマの不良率は1.5%にも相当することになる。だから品質が第一」とインフィニオンテクノロジーズ(Infineon Technologies)のPackage Concept & Definition部門シニアスタッフスペシャリストのStefan Macheiner氏(図1)は言う。クルマを故障なく動作させるため、耐久性の高いパッケージ技術が求められる。
ECU(電子制御ユニット)内の回路基板上に実装された半導体製品は、電気的に、しかも熱的にもきっちりと接続されていなければならない。故障に至る原因をまとめると、以下のようになる;
・モールドとチップ界面の剥がれ
・メタルの変形
・チップのクラック
・ボンディングワイヤの剥がれ
・チップの剥がれやボイドなど
・パッケージのクラック
・ハンダ部のクラック
・不十分な濡れ性
・ウィスカーの成長
・モールドとダイパッドとの剥がれ
・パシベーション膜のクラック
パワー半導体では大電流を流すことで温度が上がるため、熱をいかに逃がすかということも大きな問題となる。電気抵抗と熱抵抗を減らすと共に、高温と低温の繰り返しにも耐えるような材料や接合技術も求められる。しかもコストを上げない。このために熱伝導率の高く、熱膨張係数がシリコンに近い材料を使う、といった技術が基本となる。
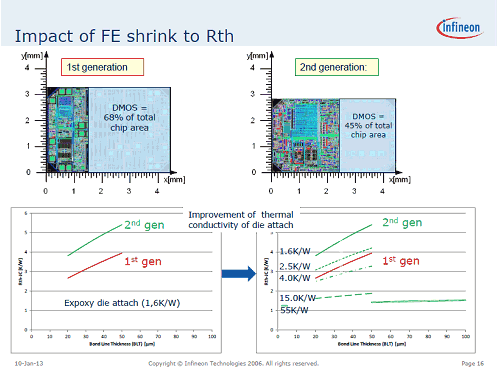
図2 パワーICではパワートランジスタ部分の面積が減少する 他の回路に多くの機能を集積するためだ 出典:Infineon Technologies
特にパワーICでは、パワーMOSFETであるDMOS部分の面積は技術の進化と共にチップ全体に対する割合が減少していくという。あるパワーICチップではDMOS部分が68%だったが、第2世代のチップでは45%に減るとしている(図2)。もちろん、パワートランジスタ部分の面積が減ると熱抵抗が上がることにつながる。このためダイボンディング材料を薄くし熱抵抗を下げると共に、熱抵抗の低い材料に替えていく。
材料候補の一つとして、銀ナノ粒子ペーストがある。拡散を利用するハンダや、Zn(亜鉛)ベースのハンダなどのダイボンディング材料と比べ、熱伝導率が2倍以上高い(図3)。Pb(鉛)ベースのハンダは、欧州の環境規制ROHS指令のためもはや使えない。従来の銀ペーストはエポキシ樹脂に溶かしたものだが、銀ナノ粒子ペーストはメタルを直接シンタリングで接合させる技術だという。ただし、まだ開発中のようだ。
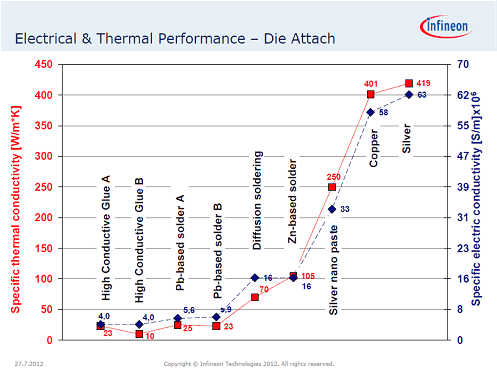
図3 各種ダイボンディング技術 出典:Infineon Technologies
開発したパッケージTO-LL(リードレス)では、ボンディングワイヤを接続するリードフレームの高さをチップ表面の高さに近づけ、湾曲部を短くした(図4)。これにより、ワイヤそのものが短くなると共にインダクタンスも減るため、より高速の動作が可能になる。また、収容するパワーMOSFETのソース部のワイヤ数を従来の4本から5本に増やした。このことで熱抵抗を減らせると共にインダクタンスも減らせる。熱抵抗は30%減少し、定格電流を50%増やすことができるとしている。
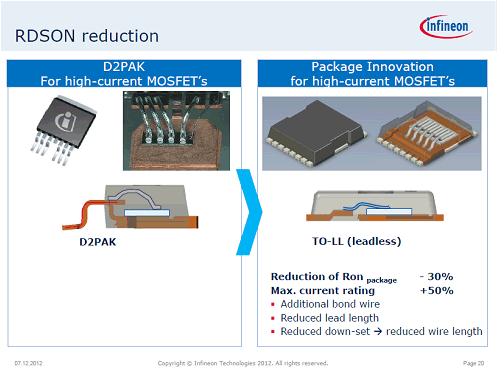
図4 開発したTO-LLパワーデバイス用パッケージ 出典:Infineon Technologies
インフィニオンは、このリードレスパッケージをプリント基板に実装する場合のハンダのフィレット形成についても検討している。特に下地のメタル端子とリードメタルの濡れ性を良くするようにハンダを形成しなければ、クラックが入ったり剥がれたりする。特に自動車メーカーからハンダの濡れ性検査の要求が強い。ハンダの濡れ性を検査する方法としてX線を使う方法は確立しているが、インフィニオンは光学カメラを使った自動検査システムを開発、実用化し始めているとしている。
将来のSiCやGaNなどのパワー半導体の実装方法も研究している。ダイボンディング法や両面冷却技術、メタル厚さの最適化などについて検討中としている。


