PoPこそベストソリューション、TSVの時代は当分来ない、テセラのPoP戦略
米テクノロジーライセンス会社のテセラは、今後もPoP(パッケージオンパッケージ)が携帯機器向けアプリケーションプロセサとメモリーの3次元実装パッケージの主流になるとし、そのための薄型化技術とフリップチップがしばらくは続くと見ている。TSVを使う3D実装は低コスト化のメドがいまだに見えず、主流にはなりえないだろうとし、PoPビジネスに注力している。
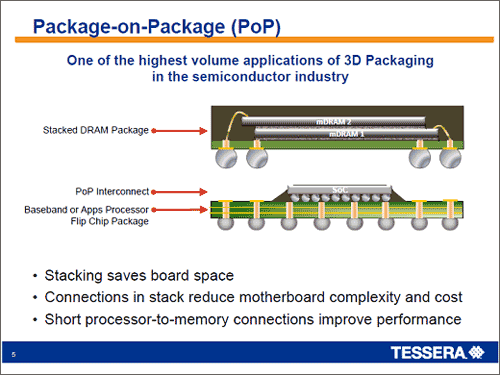
図1 PoPの基本構造 出典:Tessera社
PoPが活躍できるのは特に携帯機器だ。アプリケーションプロセッサとメモリーを縦に積む構造では、プリント基板スペースを節約でき、信号パスが短くなるため性能は上がり消費電力が下がる。しかも3次元のTSVと比べ、コストは安い。性能・消費電力だけでみると確かにTSVの方が優れている。しかし、ウェーハ同士でスルーホールをつなげてしまうため、歩留まりは確実に落ちる。不良品も一緒に接続処理してしまうためだ。これに対してPoPは、良品チップだけを実装できるため歩留まりが大きく落ちることはない。このため安い、と同社先端パッケージ技術担当副社長のフィル・ダンバーグ(Phil Damberg)氏は言う。
ダンバーグ氏は、2013年までにPoPパッケージ製品は5億個/年に達すると見ている。これらのメリットだけではなく、今後のプロセッサがますますマルチコア化してバンド幅が広がり、ピン数がますます増加する傾向にあることもPoPパッケージを加速させることになるとしている。現状においても、スマートフォンのアプリケーションプロセッサとメモリーとの1パッケージ搭載にも使われており、今後のスマートフォン、薄型デジカメ、ネットブックのようなモバイルPCにもさらに入り込んでいく。
そのドライバとなるのが、携帯機器におけるHD(high definition)化だ。フルHD(1080p)を30フレーム/秒でエンコーディング、デコーディングするとなると、高速のDDR3などのDRAMを2チャンネルで使うようになる、とダンバーグ氏は見ている。2〜3コアのマルチコアプロセッサによってメモリーバンド幅は広がり、アプリケーションプロセッサの各コアが各高速DRAMをアクセスすることでスピードを上げるようになると、プロセッサとメモリーをできるだけ近づけ、性能・消費電力を改善できる。こういったPoPパッケージには、ストレージやプログラムメモリーとしてのNANDやNORフラッシュも同時に搭載する。
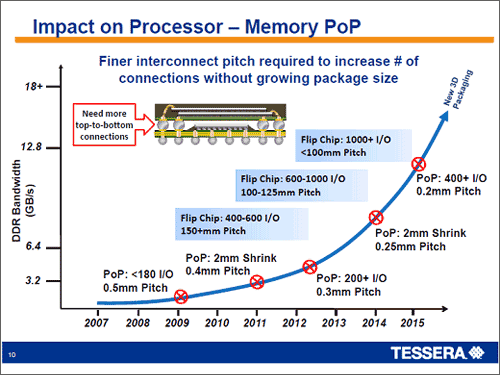
図2 多ピン化と3次元実装化はPoPがけん引 出典:Tessera社
PoPの多ピン化が要求されるようになると、フリップチップで実装するようになるが、はんだボールは温度サイクルなどの応力を吸収するという役割がある。このためはんだボールを使うPoPは多ピン化に対しても有利ではあるが、端子ピッチの微細化には対応しにくくなる。というのは、はんだボール同士がくっつきやすくなるためだ。もちろん、ワイヤーボンドは、周辺面積が大きくなり多ピン化には向かない。
そこで、テセラが持っている技術としてμPILR(マイクロピラーと発音)が登場する。これは狭いピッチで基板上に富士山状の細い銅のピラー(支柱)を形成する技術だ。そのCuピラーの上にBGAやCSPのはんだボールが乗っかる形になる。はんだボールはピラーの形状に沿ってくっつくため横方向には広がらない。このため微細化に向く。μPILR技術を使ったフリップチップのPoPの断面は下の図のようになる。
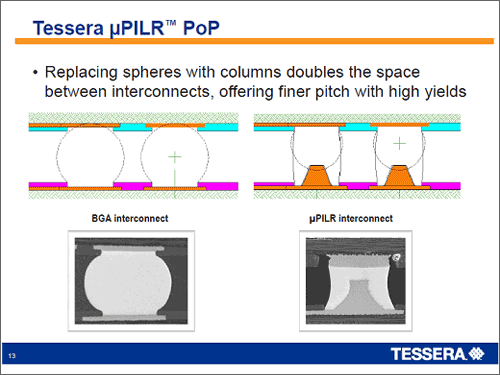
図3 μPILR技術を使ったフリップチップのPoPパッケージ断面 出典:Tessera社
TSVのようにCuだけでチップ同士を接続する場合には「信頼性の問題がある」(ダンバーグ氏)。この先Low-k絶縁膜がロジックやDRAMにも使われるようになると、さらに機械的に弱いため信頼性問題は厳しくなる。この点、はんだボールとμPILR技術ははんだが応力を吸収するため、Low-k絶縁膜に大きな力は加わらなくて済むようになる。ここでもPoPはTSVよりも有利だ。

図4 温度サイクルやエレクトロマイグレーションにμPILR技術は強い 出典:Tessera社
TSVはもっと先に来ると同氏は見ており、実用化されるためにはコスト高だけではなく信頼性についても解決しなければならないとする。Cuをビアに埋め込むとその温度サイクル試験などでクラックやハガレの問題がある。シリコンとCuとの熱膨張係数の差が大きいためである。もちろん、性能的にはPoPよりも良いため、実用化にはまずハイエンドサーバーをはじめ高価な応用分野から始まるのではないかと、ダンバーグ氏は見ている。


