GaN結晶からウェーハにスライスするレーザー技術で生産性を上げる
GaNパワーデバイスがすでにスマートフォンの急速充電器などに使われているが、GaN結晶の加工にもメドがついたようだ。SiC同様、GaNバルク結晶も固く、バルクのインゴットからウェーハにスライスすることが難しかった。ディスコが比較的簡単にスライスできる技術を開発、ウェーハとして使える収量も37.5%増やせることがわかった。
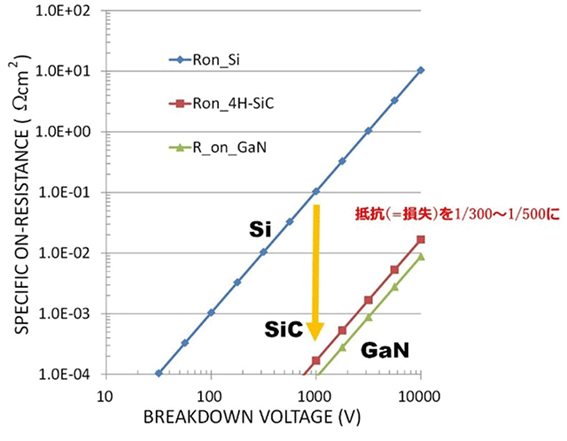
図1 パワー半導体デバイスの耐圧とオン抵抗 出典:名古屋大学
GaNパワートランジスタはHEMT(高電子移動度トランジスタ)構造が多く、電流はチップ表面に沿って横方向に流れる。しかし、SiC MOSFETやSi IGBTのように、バルクを利用して縦方向に電流を流すような構造にすると耐圧は1200V以上とれる上に、電流も多く流せる。また、パワー半導体に欠かせない特性であるオン抵抗はSiCよりも小さく、ロスが少ない(図1)。しかし、結晶作りが容易ではない。欠陥が多く、しかも結晶成長に時間がかかるからだ。
GaNはSiC結晶と同様、機械的に固いという特長があり、結晶ブール(インゴット)から複数のダイシングソー刃でウェーハ状にスライスしていくが、薄く切り出すことが難しかった。ディスコは、GaN結晶インゴットの表面から内部に焦点を合わせ、レーザーをスキャンしながら全面に照射する方法を使い、表面部分をウェーハとして剥離する技術を開発した(図2)(参考資料1)。同社はSiC結晶で培ったウェーハに切り出すKABRAと呼ぶ技術(参考資料2)をGaNに応用した。
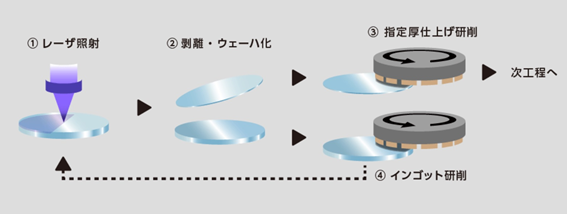
図2 ディスコが開発したレーザー照射によるウェーハ剥離技術 出典:ディスコ
従来のようなワイヤー加工による方法では、ウェーハ表面に厚さ40µm程度のうねりが発生し、それを除去するためにラッピング研磨が必要だったが、今回のKABRA法ではこのラッピング研磨工程がいらない。ただし、ユーザーが指定する厚さに仕上げる研磨は必要。その結果、従来のワイヤー加工では8枚のウェーハしか取れなかったインゴットから11枚取れるようになると共に、1時間当たりのウェーハ生産枚数が従来なら1枚だったのが6枚可能になった。研削に伴う材料の損失も従来の100µmから60µmに減った。ウェーハへの加工時間も大幅に減少し、コストを下げられるようになる。
この技術に関する特許は、出願中を含み34件あるとニュースリリースでは述べているが、同様にレーザーを用いてGaN結晶をウェーハにスライスする技術は名古屋大学未来材料・システム研究所の天野浩教授、田中敦之特任准教授らのグループでも開発し、2022年5月に発表している(参考資料3)。
名古屋大学のグループは、1枚のウェーハに剥離する技術について述べられており、レーザーを照射した後、ウェーハとなるべき部分に貼ったテープを通して支持基板で保持し引きはがすという方法を使っている(図3)。ウェーハ厚は50µm程度であるため、ウェーハにデバイスとなる動作層が形成されている場合でも使える。実験では厚さ450µmのウェーインゴットから、50µmの厚さのウェーハに加工している。
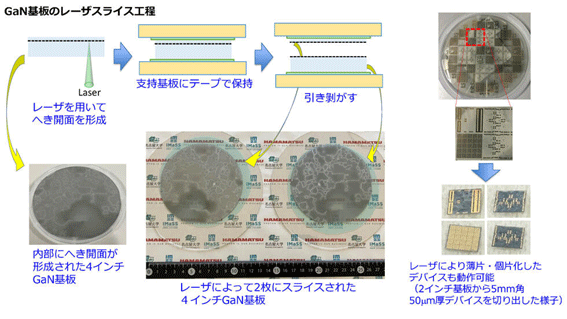
図3 GaN基板をレーザーによってスライスする技術 出典:名古屋大学
実は、この手法は、Infineon Technologiesが2018年11月に買収したSiltectra社が開発したCold Split技術に似ている(参考資料4)。この技術は、厚さ350µmのSiCウェーハ上にデバイス領域を作った後にデバイス領域分のウェーハをはがす技術である。SiCウェーハ表面上にレーザーをスキャンしながら照射した後、ウェーハ支持用のテープを張る。その後、冷却すると支持テープに張り付いた部分を、ウェーハとして分離しはがすことができる。ウェーハ枚数を増やすことができ、SiCだけではなくGaNにも適用できると述べている。
こういった技術は、ウェーハを切り出す厚さの深さにレーザーの焦点を絞り、レーザーをウェーハにスキャンしながら照射すると、焦点のあった内部の化合物半導体結晶が部分的に分解し、はがれやすくなる。焦点は結晶内部に定めるため表面上のデバイス領域が形成されていても使える技術である。はがす方法は各社まちまちだが、この手法はウェーハ枚数を増やせるため、従来の方法よりもコストを下げることができるようになりそうだ。
参考資料
1. 「GaNウェーハ生産に最適なKABRAプロセスを開発」、ディスコ (2023/07/03)
2. ディスコ社KABRAプロセスの説明
3. 「ロスなく短時間でGaN基板レーザスライス技術を発明」、名古屋大学 (2022/05/31)
4. "SILTECTRA – Innovative Splitting Technologies", Infineon


