EUVリソグラフィ光源、100Wが射程内に
EUVリソグラフィ光源メーカーのギガフォトンは、最大出力92WというLPP(レーザー生成プラズマ)光源試作機を開発した。従来のLPP光源は43Wだったため、2倍以上のパワーを得たことになる。
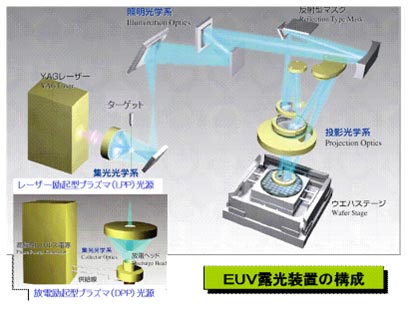
図1 EUV露光の概念図 出典:ギガフォトン/EUVA
EUVリソグラフィの最大の問題は、光源の出力が小さいことだった。出力が小さければ、レジストを感光させる時間がかかり、ウェーハを露光する時間もかかってしまうため、スループットが上がらない。このためArFレーザーリソグラフィを2回露光あるいは1回露光+セルフアラインメント加工によるダブルパターニングが優勢だった。手間をかけても、ArFリソの方がスループット、すなわち生産性の点で優れていた。
今回、EUV光源の出力が100Wに近い92Wが得られたことは、EUVの生産性向上の道が開けたことになる。ギガフォトンは、「(リソグラフィメーカーの)ASMLの報告では、70Wで52枚/時とあったので、92Wでは約60枚/時、従来の43Wだと約40枚/時に相当する」とみている。
EUVの13.5nmというX線光は次のようにして発生する。Snを高温加熱して液滴(ドロプレット)として垂らしながら、CO2レーザーを照射しプラズマを発生させ、Snイオン状態になったSnがEUV光を発する(参考資料1)。ドロプレットの直径が小さいほどプラズマ温度が高くなり、イオン化効率が高まるという。
92Wという出力が得られたのは、まずSnのドロプレットの直径を20µmと、従来の30µmよりも小さくした。ここにレーザーを照射するのに2段階の方法を使う。この方法は2008年に開発している。これは、出力の低いYAGレーザーをまずドロプレットに照射して、細かいミスト状に砕き、さらに大出力のCO2レーザーで加熱し蒸発させ、EUV光を発生する。加えて、EUV光がウェーハに到達するまでの途中の反射ミラーでの劣化を防いだ。具体的には、イオン化したSnを超電導磁石の磁力線で捕捉し、排出することによってミラーへのSnの付着を抑制し、それでもミラーに付着したSnをH2ガスによりエッチングで除去した。
ギガフォトンは量産用EUVスキャナーの実現に向け、2014年末までに150Wの出力、最終的には250Wの出力を目指すとしている。開発には新エネルギー・産業技術総合開発機構(NEDO)の支援を受けている。
参考資料
1. 溝口計「半導体露光用EUV光源開発の進展と最新動向」


