ノリタケ、熱膨張率を下げたCuペーストをNEDOプロジェクトで開発
ノリタケカンパニーリミテドは、NEDOの支援を受けた「低炭素社会を実現する新材料パワー半導体プロジェクト」において、ファインセラミックス技術研究組合の一員として、温度サイクル試験に強いCuペーストを開発した。-40〜+250℃を1000回クリアしている。

図1 ノリタケが開発したCuペースト セラミック基板にCuを付けてもはがれない
このCuペーストは、SiC MOSFETやSi IGBTなどのパワー半導体と熱伝導率の高いセラミックの間や、放熱フィンとセラミック基板との間に塗る接着剤。従来、最大250℃という高い温度サイクルを繰り返すと、接着剤が剥離することがあった(図1)。原因は、セラミックとCuとの熱膨張率の差が大きいためであった。Cuの熱膨張係数は17ppm/℃、これに対してセラミックは3~7ppm/℃、SiNセラミックだと4ppm/℃と大きく違う。
このCuペーストは、直径数µm単位のCu粒子に膨張係数の差を緩和するためのフィラー材を充填し、有機溶剤に溶かしたもの。フィラーは数%で効果があるという。セラミックとの接着には、Cuペーストを塗った後、500℃以下で焼成し固めている。Cuペーストの熱膨張係数は11ppm/℃とCuプレートよりも下がった。
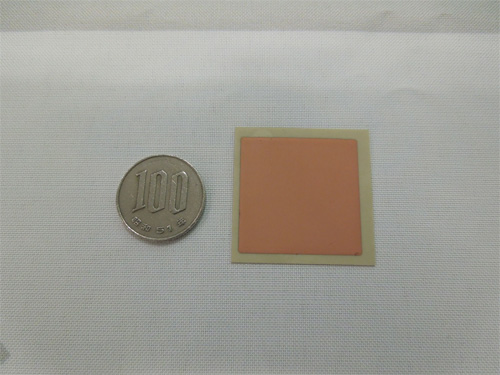
図2 SiNセラミックにCuペーストでCuプレートを付けたサンプル
ノリタケは、セラミック基板(SiNやAlNなど)にCuペーストを塗りCuプレートを積層した構造のテストサンプルを作り(図2)、温度サイクル試験を行った。パワーエレクトロニクスの実装基板への応用を狙っている。


