Infineonのパワー半導体、新パッケージ技術で差を付ける
パワー半導体に力を入れているInfineon Technologiesは、そのプロセス工場で300mmウェーハの生産を始めたが、パッケージに関しても新しいコンセプトを次々と打ち出している。例えば、ボンディングワイヤーを使わずにCuピラーを用いて、パワートランジスタとドライバトランジスタの回路を接続するというマルチチップパワーパッケージ技術を、7月17〜19日東京で開催されたTechno Frontier2013で公開した。

図1 SiチップをCuピラーで接続 出典:Infineon Technologies
DrBlade(ドクターブレード)と呼ぶこのパッケージは、パワートランジスタと、それを駆動するドライバ回路、DC-DCコンバータなどを1パッケージに実装する一種のマルチチップパッケージ技術である。マルチチップ実装であるが、チップとリードフレームとの間を、ボンディングワイヤーを使わずに、Cu(銅)ピラーで直接圧着する。この結果、ワイヤーによるインダクタンス成分が小さくなるため、ノイズが減少する上に、熱伝導率の高いCuによって放熱が良くなる。
このパッケージは、リードフレーム上に実装しており、Cuを経て上下、両面に冷却用の放熱板を設けることができる。さらに、MOSFET(CoolMOSと呼んでいる)を形成した300mmのSiウェーハを薄く削っている(図2)。これにより熱抵抗が下がり電流をたくさん流せる。Cuピラーはメッキで形成する。パッケージ全体で放熱は20%改善され、パッケージサイズは5mm角程度と小さい。300mmウェーハは200mmと比べ、ウェーハ1枚当たりのチップ収率は2.5倍も上がったという。300mmウェーハでパワーMOSFET半導体を作っているのはInfineonだけだ。
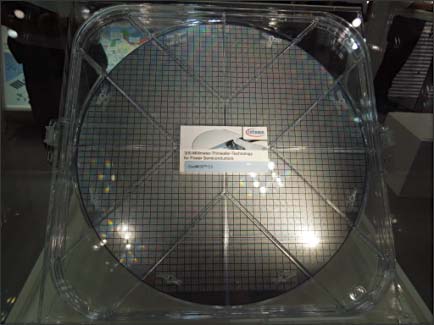
図2 Infineonのパワー半導体は300mmウェーハで作製
DrBladeというネーミングはブレードサーバーと同様、刃のように薄いという意味から来る。これを使ってIntelのCPUの電圧を制御するというデモを行っている。IntelのUltrabookでは、少しでも消費電力を下げるため、電圧をこまめに制御し使用状況に応じて変えている。DrBladeのDC-DCコンバータではCPUからの制御信号により、5mVステップで電圧を調整している。デジタル電源にして外付け部品を不要にした。また高速のリカバリを実現するため、電流の立ち上がりは、600A/μsと急峻だ。
InfineonはさらにTOLL(TO Leadless)と呼ぶ、パワートランジスタ用表面実装パッケージも見せた(図3)。これは、D2PAKと呼んでいた同社のTO-263パッケージと同じヒートシンクを使いながら、表面実装のガルウィング部分をカットしたQFNのような形に近い。実装面積が小さくなり、背面のヒートシンクを利用することで放熱効果を高めることができる。

図3 Infineonが提案する高密度実装可能な新型パッケージTOLL
このパッケージは実装面積を小さくできるというメリットから並列動作により、電流容量を増やすことができ、図3で示したフォークリフトにも使われているとしている。リードがない分、インダクタンスがガルウィングでは5nHあったが、今回1.2nHへと小さくなった。フォークリフトでモータ駆動に使い、評価した。図3の放熱板の付いたプリント基板に30個のCoolMOSを実装し3相モータ制御に使い、300〜800Aという大電流を流すことができる。
この写真からは見えないが、リードの先端の爪を窪ませており、ハンダが理想通りに流れてフィレットが形成できるようにしている。同社は今後、このTOLLパッケージを標準化するためにIEEEなどに提案していく。


