メンターグラフィックス、熱設計のボトルネックを表示するCAEツールを発表
米EDAツールメーカーのメンターグラフィックス社は、プリント配線基板や半導体実装基板の熱解析する場合に熱流のボトルネックを発見し、熱抵抗を下げるためのショートカット対策も打てる、という使い勝手のよい熱解析シミュレーションツールを開発した。これまでの熱解析ソフトは熱分布を求め、可視化するだけだったが、今回のソフトは対策までも評価できるというもの。
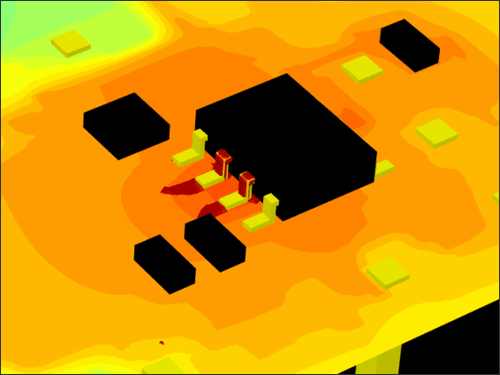
図1 赤い部分が熱の流れの悪いボトルネックを示す 出典:メンターグラフィックス
今回メンターが開発したFloTHERM version 9は、従来の熱解析ソフトであるFloTHERMの上に、ボトルネック発見機能とショートカット対策機能を実装したもの。シリコンチップを開発、パッケージ基板に実装する場合でも、パッケージ封止したICをプリント基板に搭載する場合でも、どの部分の温度が高いのかを知るだけではなく、どこがボトルネックになって熱流が妨げられているか、を表示する。
これまでのICパッケージやプリント基板実装向けのツールでは熱伝導を調べるため、ICチップの熱の温度分布は表示できる。このためどこが最も熱いということは理解できる。しかし、空気という熱流が完全に止まってしまう材料(気体)があるとその部分を表示できない。しかし空気のような熱抵抗の大きな材料は熱流のボトルネックとなりやすい。
今回のv9ツールを使えば、熱流のボトルネックを赤で表示する(図1)。ボトルネックとなりうる場所を色分けして、最も危険な場所を赤で表示し、優先順位の低い所ほど赤から青系へと色を変えていく。この結果、ユーザーは一目で最も優先順位の高いボトルネックを解消すべきことがわかる。
プリント基板に開発したICを搭載した様子をFloTHERMのボトルネック機能を使ってシミュレーションすると、熱のボトルネックや、熱的にショーカットすべき場所を表示してくれるため、設計時間が早まり、開発コストの削減と納期の短縮を達成できる。プリント基板に実際に搭載して調べると時間がかかりすぎる。
では、このボトルネックをどのようにして計算し表示しているのか。熱流が細くなっている所がボトルネックといえる訳だが、ボトルネックにおける熱抵抗の不連続の大きさは熱勾配として表し、熱流のベクトルと温度勾配のベクトルとの内積に両者の向き(Cosθ)をかけた方程式で表している。
Bn/Bn(max) = |Heat flux|*|Grad T|*|cosθ|

図2 ボトルネックを表現するための実験 出典:メンターグラフィックス
つまり、ボトルネックとしての優先度の高いBnは熱流の向きと温度勾配の向きがどのくらいの角度が離れているか、を表している。温度勾配という考えを導入したのは、次のような実験に基づいている。発熱源が100Wで銅板の端を0度に冷やした時に流れている熱はきれいに分散している(図2の左上)が、銅板の真ん中に熱伝導率の小さなプラスチックを置くとその部分だけ熱流が妨げられて赤くなる(図2の左下)。この時プラスチックの部分の温度勾配がきつくなり、発熱源の温度は90度から130度へとそのまま並行移動して上昇する。銅板の真ん中を細くしてもやはり同じような結果が得られる(図2の右上)。
上の式で、二つのベクトルに挟まれた角度θ=0ならcosθは最大値1になる。つまり温度勾配と熱流が同じ向きなら最大となり、その点がボトルネックという訳だ。Bnは最大になる値Bn(max)でノーマライズしているが、要は最も大きな値を赤で表し、徐々に下がっている点が青に近づくようにグラフィックスで表示している。
この赤くなった所に熱抵抗の低い(すなわち熱伝導率の高い)メタルをシリコンICの下に置くと、温度が下がりボトルネックは見られなくなった(図3)。

図3 気密封止パッケージの温度分布
図3のような密閉封止のパッケージにモジュールを入れる場合(図3の上)、プリント基板の下に搭載したICが最も発熱することがわかった(図3の真ん中)。そのICの下に裏面のパッケージとICとの間のギャップを埋めるようにメタルを置くと発熱は見られない(図3の下)。
このようにして、回路設計者は熱設計について配慮しなくてもこのシミュレータを使えば、最適な熱設計ができるようになる。この結果、回路設計に集中でき、より良い回路を生み出すことができるようになる。


