イー・シャトル、富士通マイクロ、D2SがEB露光機のスループットを5倍に
電子ビーム露光技術を手掛ける富士通マイクロエレクトロニクスとその製造を請け負うイー・シャトルは、電子ビーム露光向けに設計を最適化するツールベンダーの米D2S社と組み、スループットを現在より5倍以上上げていくプロジェクトを始める。このほど、3社の提携により、2009年度からEB露光ASICの受注を開始する。その前にまず、65nmプロセスによるテストチップを試作し、その有効性を実証する。
これまで富士通マイクロエレクトロニクスのグループは、EB露光によるASIC設計・製造を進めてきた。光露光といえども65nm以下のデザインルールとなるとマスクセットが設計費も含めて2~3億円と非常に高価になってきた。EB露光はマスクセットがいらないため、65nm以下のASICのリソグラフィ技術としてEB露光ビジネスを始めてきた。しかし、EB露光は1回のウェーハ露光に8~10時間もかかることがあり、スループット向上が最優先課題だった。
かつてのEB露光機は可変整形ビーム(VSB)と呼ばれる方法で、どのようなパターンも描いていた。これは、電子銃からのビームを矩形にするための第1アパーチャ、パターンを描くための第2アパーチャ、を使ってフレキシブルにどのような図形も描けた。しかし、LSI上の回路パターンすべてを描くととてつもない時間がかかってしまう。そこで、SRAMやレジスタなど繰り返し同じようなパターンには最初からキャラクタとしてパターンを、第2アパーチャに作り込んでしまうという部分一括露光という方法を使っていた。これで5倍程度にはスループットは上がったが、これでもまだ不十分。
今回、富士通グループが組むD2S社はDFEB(Design for Electron Beam)と呼ぶ方法を使い、キャラクタパターンを数多く作っておく方法である。セルライブラリからできるだけ多くのキャラクタを前もって作っておく。ライブラリとキャラクタとのマッピング作業が必要となる。これは、論理設計が終わりRTLレベルに落とす前の論理合成ツールに、セルライブラリ情報を覚えさせておく。そのようにするとどのような回路のASICにも使うことができる。EBに最適化したライブラリを多数用意することで、ランダムパターンの図形数を減らせ、結果的に全体のショット数を減らすことができる。これでスループットは現状の5倍程度に上がる。これで0.5ウェーハ/時までアップする。
今回の技術を使えば、65nmチップの開発コストはこれまでより半減できるとしている。
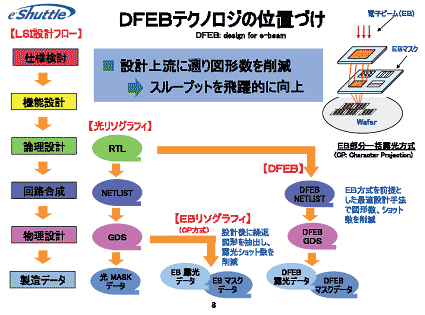
イー・シャトルの代表取締役社長、土川春穂氏によると、2010年には露光機の細かい装置改良によってスループットをさらに上げ、10倍程度の1ウェーハ/時に上げていく計画だ。さらにマルチコラムセル、マルチビーム技術により、2012年には2枚/時へと上げていき、2014年には5枚/時を目標に置いている。
米国ASICメーカーのeASIC社は配線ビアだけでカスタマイズするASICを製品化しており、富士通マイクロとイー・シャトルのEB露光機を使っている。富士通マイクロエレクトロニクス三重工場の300mmウェーハ第2工場にアドバンテスト製EB露光装置F3000を2台設置している。


