3D-ICがいよいよパソコンに載る時代へ
IntelがFoverosと呼ぶ3D-ICを使ったCore iプロセッサ「Lakefield」を発売した。CPUとメモリなどを3次元にスタックする3D-ICがいよいよ民生向けのパソコンに載ることになる。CES2020で発表されたLenovoの折り曲げタイプのPC「ThinkPad X1 Fold」と、SamsungのPC「Galaxy Book S」の2機種は間もなく発売される。

図1 ICパッケージサイズ12mm角のPC向け3次元ICプロセッサ 出典:Intel
このプロセッサLakefieldは、Core i5製品とCore i3の2種類がある。共にCPUコアは5つあり、高性能の10nm Sunny Coveコア1個と電力効率の良いTremontコア4個を集積したプロセッサとなっている。Armのbig.LITTLEアーキテクチャと似ており、高性能コアと低消費電力コアを集積し、応用によって消費電力と性能のバランスをダイナミックにとりながら、動かしていく。いずれのCPUコアとも32ビット及び64ビットWindows応用をサポートする。パッケージの大きさは、12mm×12mm×1mm(厚さ)と小さい。
この一つのパッケージに2枚のロジックチップと2枚のDRAMチップを3次元にスタックしてあり、同社はこの3D技術をFoverosと呼んでいる。ロジックチップの一つが、5つのCPUコアやメモリコントローラ、画像処理プロセッサなどを集積したチップで(図2)、もう一つが周辺回路やストレージなどを集積したチップ(図3)である。その上にメモリを4個集積したチップを2枚重ね合わせていく。合計4チップを重ねた3次元ICである。
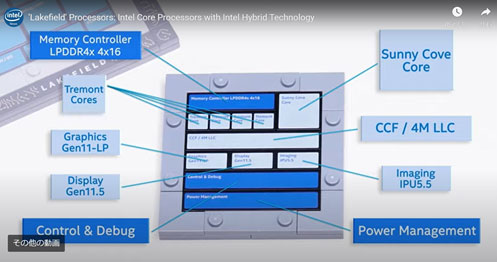
図2 小さなCPUコア4個と演算能力の高いCPUコア1個を1チップに集積 出典:Intel
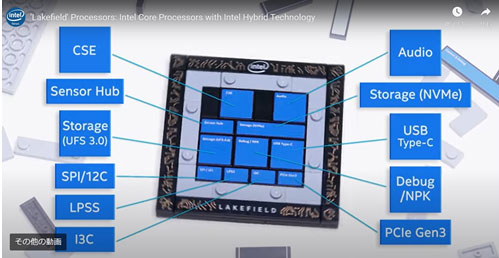
図3 ストレージや周辺回路などを1チップに集積 出典:Intel
コンピュータとして、最適なOSで最適なCPUコアを動かすために、CPUとOSスケジューラとの間をリアルタイムで通信する。このハイブリッドコアアーキテクチャによって、SoC電力当たりの性能は24%向上し、性能だけならシングルスレッドの整数演算では能力が12%向上した。またフレキシブルGPUを集積しているため、高スループットでAIを推論する場合の画像解析や様式化、高解像度化などの能力は2倍高まったとしている。もちろんグラフィックス性能も1.7倍上がったという。さらにWi-Fi6通信機能も集積している。
このFoveros技術は、無理に全てを1チップ・モノリシックに集積するのではなく、歩留まり良く集積できる程度の集積度の回路にとどめておき、それらを3次元でスタックしていく。ハイブリッドCPUといってもメモリも搭載しているので、CPUとメモリとのやりとりが極めて高速になり、性能が上がっている。メモリはPoP(Package on Package)実装している。
パソコン用のCPUとしての性能は表1の通りで、Core i5製品として、Core i5-L16G7の性能は、Intel Core i7 8500Yプロセッサと比べ、パッケージ面積は56%減り、基板ボード面積は47%減少した。
表1 Core i5とCore i3の製品の主なスペック 出典:Intel
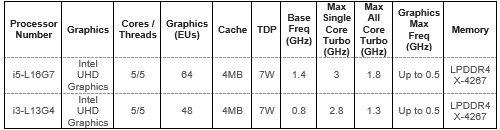
参考資料
1. Intel Hybrid Processors: Uncompromised PC Experiences for Innovative Form Factors Like Foldables, Dual Screens (2020/06/10)


