Samsung、DRAMアレイを12枚TSVで積層、24GBのHBMをまもなく量産へ
Samsungは、12枚のDRAMアレイチップを積層し、TSV(Through Silicon Via)で接続した24GBのHBMデバイスを開発、ハイエンド市場向けにまもなく量産すると発表した。TSVで穴をあけた総数は6万個以上に達するとしている。
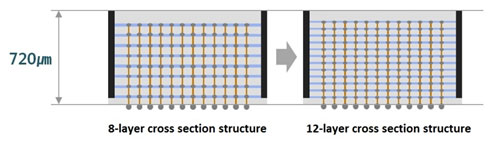
図1 Samsungが開発したHBMメモリは12枚をTSVで接続 出典:Samsung
これまでは8枚のDRAMチップをTSVでつないだHBM2製品はあったが、12枚はこれが初めてという。12枚重ねてモールドでパッケージングしてもパッケージの厚さは、従来の8枚構成と同じ720µmにとどめた(図1)。量産中のHBM2製品は1枚が8Gビットのメモリ容量で8枚重ねた8GBだったが、今回開発したHBMは1枚が16Gビットのメモリで12枚重ねて24GBとなる。
このメモリセルアレイは、最下層のアレイを経て、プリント回路基板の裏側に実装するメモリコントローラにつなぐ(図2)。ワイヤボンドで接続する場合に比べ、配線経路がぐんと短くなりメモリは高速にアクセスできるようになる。メモリアレイへのアクセスはコントローラを通して行う。
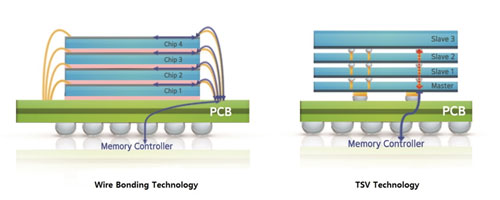
図2 DRAMセルアレイを12枚積層しアクセスはプリント版の裏面に設けたメモリコントローラから行う 出典:Samsung
Samsungはメモリではもはやムーアの法則が成り立たず、3Dで集積度を上げるしかないとして、3D-TSV技術によるDRAM開発を進めている。HBM方式はメモリ容量とアクセスするバンド幅を広げるという二つの効果があり、これからのDRAMはHBM方式に向かうようだ。まずはデータセンターを中心とするHPC(High Performance Computing)とAIプロセッサ周りのハイエンド用途にHBMを使う。ただし、SamsungはHBM2.5なのかHBM3なのか、明らかにしていない。
HBMではメモリコントローラがカギを握る。HBMのメモリコントローラを設計しているファブレスのNorthwest LogicをRambusが買収して手に入れ、HBMをRambusが販売できるようになった。RambusはNorthwestのメモリコントローラを設計し、製造はSamsungなのかTSMCなのか、Rambusの意向にかかっている。
参考資料
1. Samsung Electronics Develops Industry’s First 12-Layer 3D-TSV Chip Packaging Technology


