3D-ICがパソコンレベルにやってきた
TSV(Through Silicon Via)を使い、シリコンチップを積み重ねて配線電極を貫通させる3次元ICは、TSV工程のコスト高が問題でなかなか普及しなかった。これまでDRAMセルアレイチップを積み重ねた3次元ICであるHBM(High Bandwidth Memory)は、ハイエンドのHPC(High Performance Computing)分野でしか使われなかった。それがパソコンレベルに降りてきた。
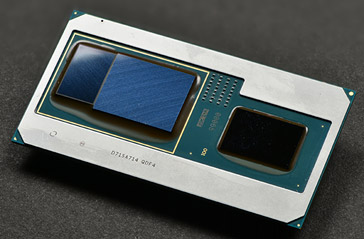
図1 IntelのCore プロセッサ(右)と、AMDのGPU Radeon(中央)、積層したDRAMのHMB 2(左)を集積したプロセッサボード 出典:Intel
これは、Intelが、パソコン向けのプロセッサで最新の第8世代Coreシリーズと、AMDのグラフィックスチップ(GPU)のRadeon RX Vega M Graphicsと、HBM2を同一パッケージ基板に搭載したプロセッサを発表したもの。Intelがかつて法廷論争まで繰り広げた、かつてのライバルAMDのGPUを搭載したということも面白い。AMDは2006年にカナダのグラフィックス半導体メーカーのATI社を買収したことでGPUを手に入れた。Intelのプロセッサパッケージは、DellとHPのモバイルパソコンや薄型軽量の2-in-1パソコン、さらにIntel NUC(Next Unit of Computing:4×4インチサイズの小型PC)に搭載されている。
このプロセッサパッケージに搭載されるHBMの容量は4Gバイト(32Gビット)。これら3つの主要チップを搭載するプリント回路基板は、IntelがEMIB(Embedded Multi-die Interconnect Bridge)と呼ぶシリコンチップ内蔵基板である(図2)。これは、基板上に配置したGPUとHBMを近づけて搭載できるようにするため、シリコンのインターポーザよりもずっと小さなチップに再配線を施し、そのチップを基板に埋め込んだ2.5D技術。GPUとメモリとの間での頻繁なやり取りを行うため、この実装法はGPUの演算速度を高めることができる。また、従来のシリコンインターポーザよりも小さな面積で済むため、低コストで実装できる。

図2 Intelのチップ内蔵基板EMIB技術 出典:Intel
これをパソコンに持ってきたのは、従来ならデスクトップレベルでゲームを楽しんだり、ゲームコンテンツを作成したり、VR(仮想現実)に熱中したりするような、グラフィックスをふんだんに使うユーザーがノートパソコンで楽しめるようにするためだ。GPUやCPUを、ICパッケージではなく一般のプリント回路基板に実装していた3年ほど前のパソコンと比べると、フレームレートは最大3倍に向上し、消費電力は半減したという。また、小型化に関しては、最大40%小さくなったとしている。
参考資料
1. New 8th Gen Intel Core Processors with Radeon RX Vega M Graphics Offer 3x Boost in Frames per Second in Devices as Thin as 17 mm (2018/01/07)


