AMD、3D-ICメモリをインタポーザに搭載した2.5Dモジュールを開発
メモリメーカーのMicron TechnologyがDRAMを3次元的にTSVで積層するHMC(Hybrid Memory Cube)について、SPIフォーラム「3次元実装への道」で紹介したが、AMDはコンピュータシステムを高速動作させるためのTSVによる、新しい2.5D IC技術を明らかにした。
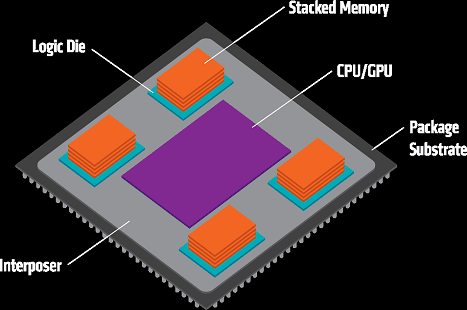
図1 AMDが開発したHBMメモリ利用の2.5D-IC 出典:AMD
AMDは、HBM(High Bandwidth Memory)と呼ぶ積み重ねるDRAMをTSV(Through Silicon Via)でつないだICと、CPU/GPUなどを集積したSoCを、インタポーザを介して接続する2.5次元技術を発表した。CPUやGPUに大容量DRAMを1チップ集積することは経済的に意味がない。またDRAMを遠く離して配置すると、配線負荷が重くなり速度は上がらず、消費電力も増す。例えば、グラフィックス描画作業を行う場合、これまではGDDR5が使われてきたが、GDDR5のバンド幅を広げGbpsと高速になると、消費電力は許容できないほど増大してしまうという。このためHBM(広いバンド幅のDRAM)をCPU/GPUの近くに配置して広いバスでつなぐことが高性能コンピューティングの最適解となる。特に、スタックしたメモリを御CPU/GPUを近づけて配置する(図1)と、1W当たりのハンド幅を大きくできる。すなわち電力効率を高められる。
AMDは、インタポーザを利用する2.5Dの量産システムを台湾のASEと韓国のAmkor、台湾のUMCと共同で開発した。HBMチップはTSVでシリコンを貫通させ、裏面にはマイクロバンプで次のHBMチップをつなぐ(図2)。この構造は、高バンド幅のHBMとCPU/GPUを接続するためのインタフェースをロジック回路で構成し、そのロジックチップをHBMメモリの下に配置する。HBMはインタポーザを通じて、CPU/GPUを接続する。AMDは、HBMの最初の完成した仕様と試作品を韓国のSK Hynixと共同で定義し開発した。
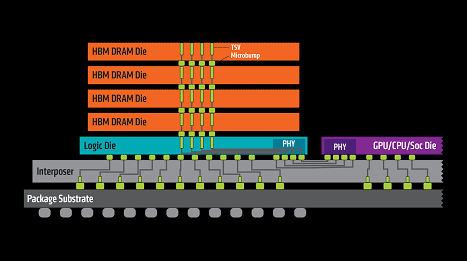
図2 HBMメモリとロジックをTSVとマイクロバンプで3次元化、インタポーザで2.5D-ICシステムを構築 出典:AMD
HBMの最大のメリットとなるバンド幅は、1024ビットと大きく、GDDR5の32ビットと比べ32倍も広い。また、クロック周波数は、GDDR5が最大1750MHz(7Gbps)と大きいが、HBMのそれは500MHz(1Gbps)と下げ、消費電力を抑えている。この結果、GDDR5ではチップ当たりのバンド幅は28GB/sだが、HBMスタック当たり100GB/s以上となる。ワット当たりのGB/sは、GDDR5が10.66GB/sに対して、HBMスタックでは35GB/sになり3倍以上電力効率が高まる。
また、コンピュータシステムの小型化にもなる。HBMでは4チップのDRAMをスタックすると5mm×7mmと小さいが、同じ1GBの容量を従来のGDDR5で配置すると、24mm×28mmと面積を94%減少できる。CPU/GPUチップとメモリを搭載したプリント回路基板で比較すると、モジュール面積は半分以下になる(図3)。
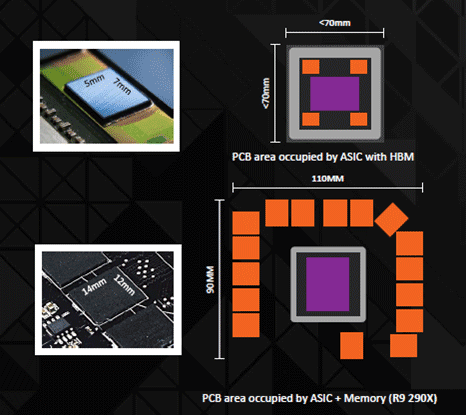
図3 電力効率の高い2.5Dシステムは小型にもなる 出典:AMD


