数1000ピンのLSIパッケージμPILRの信頼性はBGAより高いとTesseraが発表
BGAでは対応できないような多ピンのLSI を実現できるμPILR(マイクロピラーと発音)技術の信頼性が高いことがわかってきた。数1000〜1万ピンもの多ピン(多バンプ)のLSI を作り出すための新しいパッケージがこのμPILRである。開発した米Tessera Technologies社はこのほど、このパッケージング技術を台湾のKinsus Interconnect Technology社にライセンス供与すると発表した。
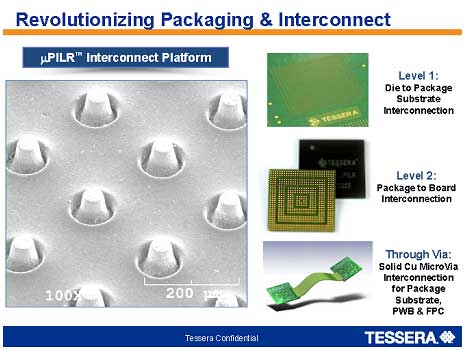
今回ライセンス供与を受ける台湾Kinsus社は、PCのチップセットやモバイルPCなどの大手企業ASUSTEK社の子会社にあたる。
μPILR技術は、ピン高が低く、しかもピンの形をしたコンタクトを持ちながら、CSPパッケージの半田ボールを置き換えられる多ピン対応の接続技術である。CSPやMCP(マルチチップパッケージ)、PoP(パッケージオンパッケージ)などの多ピン化に威力を発揮する。
従来のBGAやCSPなどの半田ボールは、接続する配線パッドにクリームハンダを塗った場所ではボールがつぶれてしまい、接続部のピッチを狭くして多数のパッドを収容できない。ボールとボールがくっついてしまう恐れがあるからだ。このためBGAやCSP技術は数1000ピンといった多ピンのパッケージには使えなかった。
μPILRバンプは、半田ボールではなくNi/Auの円錐の途中を切り取った台形の形状をしている。半田を塗ってリフローしても半田がつぶれて横に広がるような形にはならない。このためピッチを狭くしピン数を増やしても面積が広がらない。フリップチップのテスト用パッケージでは、200μmピッチで5557バンプ(ピン)、189μmピッチで6264バンプ(ピン)、150μmピッチなら10,281バンプ(ピン)と、多くのバンプ数(LSIパッケージのピン数に相当)にも対応できる。
μPILR技術はLSIパッケージのピンやバンプに使うだけではなく、プリント回路基板(PCB)やあるいはチップを搭載する基板にも使える。これまで、チップ試作基板では130μmピッチや100μm、80μmと微細なピッチのバンプも形成している。
このほど、μPILR技術の均一性の評価結果と信頼性試験の評価が明らかになった。均一性は、10,132点のμPILRバンプの高さを測定し、中央値55.4μmの高さに対して、低い方は53.2μm、高い方は56.8μmと、その幅3.6μm以内にほぼ100%のバンプが収まっている。
信頼性試験では、まず150℃、1000時間の高温エージング試験では何の変化も見られなかった。アンダーフィルをしない従来のBGAパッケージ同士を合わせたPoPパッケージとμPILRパッケージとを、落下試験と温度サイクル試験で比較した。データはワイブル分布で評価した。落下試験ではμPILRの方がほぼ2倍寿命が長く、-40〜+125℃の温度サイクル試験ではμPILRの方が50〜60%寿命が長かった。
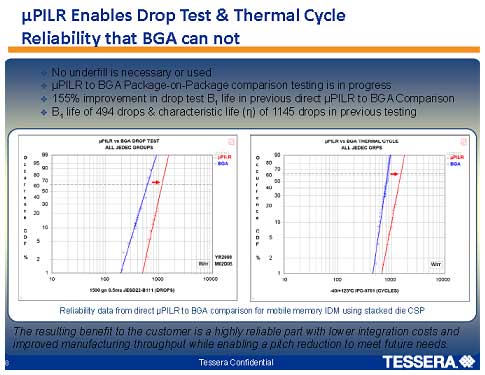
バンプを壊すまでバンプの頭を強い力で押すせん断ストレス試験では、従来の半田バンプのせん断力はスペック上45MPa(メガパスカル)だが、直径75μmのμPILRバンプだと平均102MPa、最大126MPa、最小72MPaという結果だった。破壊したμPILRバンプの断面を解析すると90%以上が合金となっている部分から折れ、ピラーの途中から折れたものは10%にも満たなかった。


