中国初の新型NORフラッシュメモリで組み込み系を狙う
中国に新しいメモリベンチャーが登場した。China Flash(中天弘宇集成電路)と呼ばれるファブレスだ。製造はファウンドリに依頼する。今から市場に入る以上、特長が必要だが、これまでの中国のメモリメーカーとは全く違う。後述するが、新開発の独自メモリ技術を持ち、元IntelのStefan Lai氏(図1)がCTOとなっている企業だ。

図1 China Flash社CTOで元Intel VPのStefan Lai
このNORフラッシュの最大の特長は、プログラミング手法を開発したことで低いプログラムエネルギーで書き込めることだ。このため消費電力も書き込み電圧・消去電圧も低くて済む。例えばプログラム電圧は3V、消去電圧は7Vと低い。しかも従来のフローティングゲート型NORフラッシュでは、短チャンネル効果のためにパンチスルーが起こりやすく、微細化できなくなるという問題があったが、新型NORフラッシュはこの問題がなく、むしろ微細化しなければメモリ効果が出ないという特長がある。しかも、読出しアクセス時間はわずか60〜90nsと速い。
プログラミング技術を紹介する前に、微細化可能な新しいNORフラッシュのビジネスモデルについて説明しよう。このNORフラッシュは、新型ゆえにIPベンダーというビジネスも別会社として用意した。これがLeWay Integrated Circuit(中宇天智)社である。なぜIPベンダーも用意したか。China Flashの狙うべき市場が組み込みメモリ分野だからである。いわばフラッシュマイコンなどがこれに相当する。フラッシュマイコンでは、フラッシュメモリ部分だけをIPとしてライセンス販売することがよく行われてきた。
新型NORフラッシュといっても、デバイス構造はシンプルで一般のフラッシュマイコンで必要なマイコンやロジックのプロセスとの互換性もある。つまり、1層ポリシリコンプロセスで済むため、従来のフローティングゲート構造で使われてきた2層ポリシリコンプロセスは必要ない。このため、プロセスコストはマイコンやロジックとほとんど変わらないため安くなる可能性が高い。
これまでのNORフラッシュがプロセス上で行き詰ったのは微細化しにくかったからだ、とLai氏は述べる。IntelがNORフラッシュメモリを世に出したのは東芝よりも早く、1986年であり、その時は1.5µmプロセスを使い、NORフラッシュメモリとは言わずETOXメモリと呼んだ。当初の用途はデジタルカメラだったが、携帯電話のBIOSやストレージへと変化していった。集積度を上げメモリ容量を増やすために微細化を進めていったが、ドレイン-ソース間のパンチスルーが起きて動作しにくくなるためこれ以上微細化できないというところまできた。これが50nm前後だった。
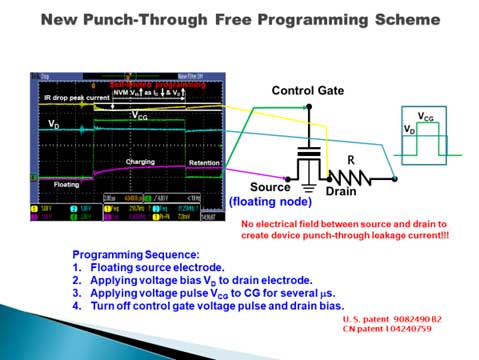
図2 新型フローティングソースのNORフラッシュメモリセル 出典:中天弘宇
新型NORフラッシュで開発されたプログラミング手法の基本的な考えは、ホットエレクトロン注入を用いたフローティングゲートに似ている。新型NORフラッシュの基本セルは、図2のようにフローティングゲートではなく、フローティングソースを採用する。通常のMOSFETのドレイン電圧を一定にして、制御ゲートCGにパルス電圧をかけると、最初はソースあるいはサブストレートからドレインへ走行する電子がドレイン電界によって加速され、ホットエレクトロンになり、ドレイン領域に行ったり、薄い酸化膜をトンネリングしたりする。ソースはフローティングなので、次第に電荷(電子)が溜まり制御ゲートをオフにしても電荷が充電された状態を保つ。しかもソース電位はドレイン電位に近づくため、パンチスルーは起きにくくなる。
このプログラミング法を別の視点から見たのが図3である。ドレインとサブストレート間の電界によってドレイン空乏層はサブストレート側に広がり、ドレイン電界に引きずられて電子がドレインやゲートトンネル酸化膜側に寄ってくる。インパクトイオン化現象がドレイン電界で起き、電子が格子にぶつかり電子・正孔対を発生し、次々に電子や正孔を増加させていく。加速された重い正孔も次々とエネルギーを得て2次電子を発生させ、トンネル酸化膜を経てフローティングゲートやソースに注入されることになる。

図3 ドレイン-サブストレート間の空乏層が基板側に広がり、フローティングソースに電荷が溜まっていく様子を示している 出典:中天弘宇
従来のホットキャリア注入の場合と比べて、数百倍〜1000倍のホットエレクトロンが注入されるため、効率よく充電できる。このためプログラム効率が上がり、消費電力は下がる、という訳だ。
ゲート長を短くすると共に、フローティングソースに電荷が溜まり、ゲートしきい電圧が大きくなっていく様子を図4に示す。130nmあたりからメモリ効果が表れてくる様子を示している。

図4 ゲート長を350nmから55nmへと微細化するのにつれメモリ効果が顕著になっていく 出典:中天弘宇
狙う応用分野が組み込み系に絞ったのは、ロジックプロセスとなじみの良いメモリプロセスにできるからだ。例えば、シングルポリシリコンゲートのロジックプロセスとの互換性を持たせるために、図5のような構造を取ることができる。
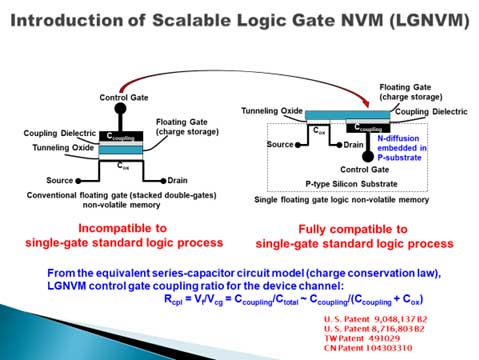
図5 2層のポリシリコン構造の上側を平面上に下ろした構造のロジックと互換性のあるセル構造 出典:中天弘宇
上の図は2層ポリシリコンゲートのフローティングゲートを共通にして、上の制御ゲートをカップリングキャパシタ酸化膜を介して基板側に持ってきた構造を示している。ゲート酸化膜のレイヤーがゲートトンネル酸化膜と、カップリングキャパシタ酸化膜を同じ薄さにすれば、2層ポリを二つに分けて平面に並べて置くような構造になる。ただし、カップリング酸化膜だけ少し厚くすることも簡単にできる。この構造だとロジック用のMOSFETプロセスと互換性が保たれる。
デバイスの製造は、台湾のUMCと中国のファウンドリGrace Semiconductorに依頼する。1年以内、すなわち20年末までに製品化にこぎつけたいとしている。組み込み用NORフラッシュは、NANDほどの容量が要らないクルマのECUやストレージ以外の用途で求められる。ただし、温度仕様を満足できるかどうかはこれからの検討となる。これまでNANDフラッシュやDRAMで韓国や日本、米国の後を追うビジネスを展開してきたが、この新型NORフラッシュは初めての中国独自のメモリ技術といえる。


