3ľ°łĶSiP•—•√•Ī°ľ•ł§ň¬śŌ—§¨őŌ§Ú∆Ģ§žĽŌ§Š§Ņ
§‚§»§‚§»łŚĻ©ńݧő∂Į§ę§√§Ņ¬śŌ—§ő»ĺ∆≥¬őłŚĻ©ńݧ¨§§§Ť§§§ŤSiP§Ú§Ō§ł§Š§»§Ļ§ŽņŤ√ľLSI•—•√•Ī°ľ•ł§ňŅ Ĺ–§Ļ§Ž°£ļ«¬ÁľÍ§őASE Groupľ“•ł•ß•Õ•ť•Ž•ř•Õ•ł•„°ľ∑ů•Ń°ľ•’R&D•™•’•£•Ķ°ľ§őHo-Ming TongĽŠ§ň§Ť§Ž§»°Ęľ°ņ§¬Ś§őSiP§ÚļÓ§Ž§Ņ§Š§ő§Ķ§ř§∂§ř§ łń ŐĶĽĹ—§¨§Ĺ§Ū§√§∆§≠§Ņ§≥§»§ň§Ť§Ž°£
īū»ń§ň•Ń•√•◊§Úňš§ŠĻĢ§ŗĶĽĹ—°Ęīū»ń§ňńŮĻ≥§š•≥•ů•«•ů•Ķ§ §…§ő…Ű… §Úňš§ŠĻĢ§ŗĶĽĹ—°Ę•¶•ß°ľ•Ō•ž•Ŕ•Ž•—•√•Ī°ľ•ł•ů•į°Ęī”ńŐĻ¶ņ‹¬≥°Ę•Ļ•Ņ•√•Į•Ń•√•◊ĶĽĹ—°Ę§»§§§√§ŅŅ∑§∑§§ľ¬ŃűĶĽĹ—§¨∆ĢľÍ§«§≠§Ž§Ť§¶§ň§ §Ž§»°ĘŅ∑§∑§§3ľ°łĶSiP§¨ņł§ř§ž§∆§Į§Ž§»§§§¶°£TongĽŠ§Ō13∆Łńę§őīūńīĻ÷Īť§«§≥§ő§≥§»§ÚĹ“§Ŕ§Ņ°£
ŅŚ Ņ ¨∂»∑Ņ§ő∆ņį’§ ¬śŌ—§«IC»ĺ∆≥¬ő•«•–•§•Ļ§ő•Ķ•◊•ť•§•Ń•ß°ľ•ů§őŇżĻÁ§¨Ņ §ŗ§»°ĘŃįĻ©ńݧő•’•°•¶•ů•…•Í§ę§ť•—•√•Ī°ľ•łÕ—§őīū»ń°Ę•∑•Ļ•∆•ŗĽŇÕÕ°Ę•—•√•Ī°ľ•ł&•∆•Ļ•»§»§§§¶įžŌʧőőģ§ž§ÚŅ∑§∑§§•≥•ť•‹•ž°ľ•∑•Á•ů§«SiP§ÚļÓ§Ž§»§§§¶§ő§ņ°£§‚§»§‚§»ASEľ“§ŌłŚĻ©ńݧőņŃ…ť•”•ł•Õ•Ļ§Ú§š§√§∆§≠§Ņ§Ņ§Š°Ę•—•√•Ī°ľ•ł•ů•į§»•∆•Ļ•»§Ō•Ņ°ľ•ů•≠°ľ•Ķ°ľ•”•Ļ§«§«§≠§Ž°£§≥§ž§ň≤√§®§∆°Ę…Ű… §š•Ń•√•◊§Úňš§ŠĻĢ§ů§ņŅ∑§∑§§īū»ń°Ę≤Ņ§Ú1•—•√•Ī°ľ•ł§ő•Ń•√•◊§ňĹłņ—§Ļ§Ž§ę§»§§§¶•∑•Ļ•∆•ŗŇ™§ ĻÕ§®§¨≤√§Ô§Ž°£
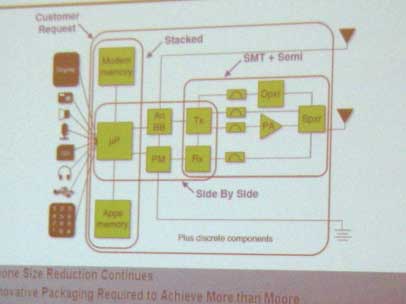
§»§≥§Ū§¨°ĘTongĽŠ§Ō°ĘŅ‚ńĺŇżĻÁ§ §ť§ŐŅŚ ŅŇżĻÁ§»§§§¶łņ§§ ż§ÚĻ÷Īť√ś§ňĽ»§√§∆§§§Ņ°£§≥§őŅŅį’§Ō°Ę°÷ASE•į•Ž°ľ•◊§Ō°Ęīū»ńņŬ§§ę§ťEMS§ř§«§‚§ő§Ň§Į§Í§őīŽ∂»§¨¬∑§√§∆§§§Ž°£§≥§ő§Ņ§Š°ĘASE•į•Ž°ľ•◊§őŅŚ ŅŇ™§ ŇżĻÁ§ň§Ť§Ž•™•ŕ•ž°ľ•∑•Á•ů§¨≤ń«Ĺ§ň§ §Ž°◊§»ľęŅģňĢ°Ļ§«§Ę§Ž°£
65nm§őłĹļŖ§ę§ťľ°§ő45nm§Ō2008°Ń2011«Į§ň§š§√§∆§Į§Ž°£§≥§ő§»§≠§ň§Ōī”ńŐĻ¶«ŘņĢ§¨§ń§ę§Ô§ž§Ž§ņ§Ū§¶§»§Ŗ§∆§™§Í°ĘASE§Ō§≥§őņŤ√ľ ¨ŐÓ§ňőŌ§Ú∆Ģ§ž§Ž§»§§§¶§Ô§Ī§ņ°£§≥§ő§Ť§¶§ ľ°ņ§¬ŚSIP•—•√•Ī°ľ•ł§ÚĽ»§¶§»°Ę•—•√•Ī°ľ•ł§őłŁ§Ķ§ŌłĹļŖ§ő1.2°Ń1.4mm§Ť§Í§‚§Ķ§ť§ň«Ų§§1.0°Ń1.2mm§»«Ų§Į§ §Ž§»§§§¶°£∑»¬”ŇŇŌ√Ķ°ň‹¬ő§őłŁ§Ķ§‚ļ£§ő14°Ń15mm§ę§ť10°Ń12mm§ň§ §Ž§»§Ŗ§∆§§§Ž°£




 •§•ů•Ķ•§•ņ°ľ•ļ
•§•ů•Ķ•§•ņ°ľ•ļ •§•ů•Ķ•§•ņ°ľ•ļ
•§•ů•Ķ•§•ņ°ľ•ļ •§•ů•Ķ•§•ņ°ľ•ļ
•§•ů•Ķ•§•ņ°ľ•ļ •§•ů•Ķ•§•ņ°ľ•ļ
•§•ů•Ķ•§•ņ°ľ•ļ •§•ů•Ķ•§•ņ°ľ•ļ
•§•ů•Ķ•§•ņ°ľ•ļ •Ľ•Ŗ•≥•ů•›°ľ•Ņ•Ž ‘ĹłńĻ
•Ľ•Ŗ•≥•ů•›°ľ•Ņ•Ž ‘ĹłńĻ »ĺ∆≥¬őīōŌĘĽ‘垧ő∆įłĢ
»ĺ∆≥¬őīōŌĘĽ‘垧ő∆įłĢ ĶĽĹ—•≥•ů•∆•ů•ń
ĶĽĹ—•≥•ů•∆•ů•ń ∑–Īń°¶ņÔő¨•”•ł•Á•ů
∑–Īń°¶ņÔő¨•”•ł•Á•ů •»•‘•√•Į•Ļ≤ÚņŌ•≥•ť•ŗ
•»•‘•√•Į•Ļ≤ÚņŌ•≥•ť•ŗ