nmスケールになってきた今こそ、コラボの時代−セマテックの呼びかけ
米国を拠点とするセマテック(SEMATECH)は、共同開発のコンソーシアムだが、ナノメータスケールの今こそ、その必要性を説いている。装置・部材メーカーにとって研究開発投資があまりにも増大したからだ。セミコンジャパン初日の基調講演でもインテルジャパンの吉田和正社長は1社で開発するのではなくみんなでコラボする時代になったと述べた。

図1 SEMATECHシニアディレクタのMichael Lercel氏
セミコンジャパン最終日には半導体研究開発コンソーシアム、セマテックのシニアディレクタであるMichael Lercel氏(図1)が製造装置・材料もナノメータ時代にはコラボが欠かせなくなる、と述べた。このコラボレーション組織を利用すれば1社当たりの開発負担は軽減されるはずだ。プロセス開発や低コスト技術の開発といったテーマでコラボレーションを進めてきたセマテックだが、今では連邦政府からの資金は1セントも入っていない。企業が資金を出し合い開発負担をシェアするようになり、コラボレーションのビジネスとして継続できるようになっている。
半導体産業は長期的には成長産業であることは変わりないものの、1社当たりの研究開発費が非常に増えてきている。製造装置メーカーの売り上げはリーマンショックで落ち込んだが、彼らの研究開発投資はやや落ちた程度にとどまった(図2)。というのは、装置市場は寡占化の方向に向かっており、大手のプレーヤーが残っているからだ。一方、装置向けのサプライチェーンの中にある部材メーカーにとっては装置市場の変動が大きすぎると同時に、研究開発投資も増やせない状況になっている(図2)。

図2 製造装置メーカーのR&Dコスト(上)は変わらないが部材メーカーのそれ(下)は景気に左右される
そこでセマテックは、部材メーカーを主な対象として、コラボレーションによって研究開発費負担やリスクを軽減しようと呼びかけている。最も資金のかかるテーマとしてEUVがある。EUVの実用化には装置そのものの光源の問題はもちろんあるが、それ以外にもマスクやマスクブランクス、レジスト開発、ナノスケールの欠陥検出などの問題も山積している。
EUVマスク検査装置の市場そのものはさほど大きくない。しかしEUVリソグラフィ技術を実用化するためにはこの装置開発は欠かせない。検査装置の開発には巨大な投資が必要となる。1社では困難であろう。レジストも同様、EUV用のレジスト開発を1社で行っていては投資の回収は難しい。マスク検査も20nmレベルの欠陥検出には開発投資額は巨大になる。
マスク関係では、セマテックにはEMI(EUV Mask Infrastructure)Initiativeというプログラムがある。量産向けのEUVマスク検査装置を選び開発するためである。欠陥の検査や修正、再チェックが注力分野である。このプログラムのカギは4つある。基板検査、ブランクス検査、パターン検査、そしてEUV AIMSプロジェクトである。4番目のセマテック-ツァイスのEUV AIMS共同プロジェクトは昨年始まり(図3)、4社の会員企業が参加している。

図3 セマテックとツァイスのEUV AIMS共同プロジェクト 出典:SEMATECH
レジスト開発では、リソグラフィ装置が欠かせないが、レジストメーカーが高価なEUV装置を購入するのは難しい。2003年にはスキャナー(リソグラフィ装置の1種)の平均価格の60倍というレジスト市場だったが、2011年にはEUVスキャナーの15倍ほどに、スキャナー1台の価格とレジスト全体の市場との差が詰まっている(図4)。そこで、セマテック内に設立したRMDC(Resist and Materials Development Center)において24時間、レジスト開発に取り組めるようになっている。2008年以来取り扱ってきた材料の累計は1万3000種類にも及ぶ。ウェーハ数は2万6000枚になる。それでもレジストメーカーから評価要求されているレジスト材料の種類は多く、その要求と供給とのギャップは依然として大きい。
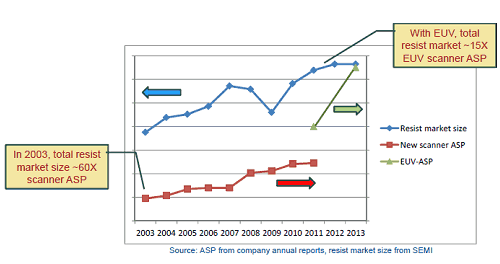
図4 レジスト市場全体はEUVスキャナー何台分?
セマテックのオルバニーでは、これまでNA0.3のレンズ(反射系)を使い、16nmのイメージングを行ってきており、露光したウェーハの数は年間6000枚に及ぶ。2013年にはNA0.5のレンズで12nm以下のパターニングを行う計画であり、年間の処理量も6000枚を超える計画にしている。レジストのアウトガスについても研究しており、ASMLのEUV装置NXE3100を使用してレジスト材料を評価している。

図5 セマテックのRMDCは2013年に12nm以下のレジストパターンに挑戦 出典:SEMATECH
20nm以下の欠陥検出は重要な技術の一つであり、今後EUVマスクブランクスにおいて欠陥の同定はカギとなる。欠陥同定・検出検査にかかるコストはこれまでの50nm程度の欠陥で数100万ドル規模だったが、20nm以下では3000万ドル規模になると見積もっている。セマテックには1億ドル相当の設備を備えたMBDCがある(図6)ため、開発投資に資金を投入できない材料メーカーにとっては高価な設備が使えるというメリットがある。

図6 セマテックではEUVレジスト開発に必要な装置を使える 出典:SEMATECH
特に、EUVは波長が13.5nmと軟X線に近いため、透過レンズではなく反射系レンズを使う必要がある。マスクブランクスではガラス基板上にSi薄膜4nm、Mo薄膜3nmを繰り返し何層にも積層していく。極めて複雑な構造になっており、傷や欠陥の入る余地が大きいため、クリーンなマスクを作り管理することが難しい。EUVの課題は多い。




 インサイダーズ
インサイダーズ インサイダーズ
インサイダーズ インサイダーズ
インサイダーズ インサイダーズ
インサイダーズ インサイダーズ
インサイダーズ セミコンポータル編集長
セミコンポータル編集長 半導体関連市場の動向
半導体関連市場の動向 技術コンテンツ
技術コンテンツ 経営・戦略ビジョン
経営・戦略ビジョン トピックス解析コラム
トピックス解析コラム